V. ФИЗИЧЕСКИЕ ОСНОВЫ СОВРЕМЕННЫХ МЕТОДОВ ИССЛЕДОВАНИЯ ПОВЕРХНОСТИ
5.1. Вторичная электронная эмиссия - основа современных методов анализа поверхности
В основе большинства современных экспериментальных методов исследования поверхности лежит явление испускания твердыми телами вторичных электронов при их бомбардировке пучком первичных электронов. Это явление было открыто в 1902 году Л. Остином и Г. Штарке, и носит название вторичной электронной эмиссии (ВЭЭ). Причина этого эффекта заключается в том, что первичные электроны, взаимодействуя с электронами твердого тела, передают им часть своей энергии. Если эта энергия достаточна для преодоления электронами твердого тела поверхностного потенциального барьера, то они покидают его и регистрируются как вторичные электроны. Вторичные электроны обладают энергиями от нуля до энергии первичных электронов. Энергетическое распределение вторичных электронов имеет сложный характер и отражает разнообразные, сложные и часто связанные между собой процессы взаимодействия первичных электронов с поверхностью твердого тела.
Энергетические спектры и угловые распределения вторичных электронов содержат достаточно полную информацию об основных микроскопических характеристиках поверхности - составе, структуре, электронном строении.
|
Рис. 5.1. Схематический вид кривой распределения вторичных электронов по энергии |
Схематически вид кривой распределения вторичных электронов по энергии представлен на рисунке 5.1. Как показывают экспериментальные результаты, вид спектра вторичных электронов практически не меняется при изменении первичных электронов. При энергии первичных электронов 100 эВ ... 1 кэВ основная доля в спектре приходится на медленные электроны (область а на рис. 5.1) эти электроны называют истинно вторичными электронами, так как эту группу составляют, в основном, электроны, выбитые из твердого тела пучком первичных электронов. Предполагается, что они возникают в результате каскадных процессов потери энергии первичными электронами. К истинно вторичным электронам условно относят вторичные электроны, энергия которых менее 50 эВ. Отношение числа истинно вторичных электронов к числу первичных электронов называют коэффициентом истинно вторичной эмиссии и обозначают обычно d. Максимум спектра истинно вторичных электронов лежит в области 1 ... 10 эВ, причем наблюдается периодическая зависимость положения этого максимума от атомного номера [1]. При достаточно больших значениях энергии первичных электронов положение максимума не зависит от Ер, однако, при Ер < 20 эВ он сдвигается в сторону меньших энергий. Если энергия первичных электронов не превышает работу выхода электронов, то спектр вторичных электронов состоит в основном из упруго отраженных электронов.
Область b на рис. 5.1. относится к неупруго отраженным электронам, число которых существенно не изменяется в зависимости от энергии. Отношение числа электронов эмиттированных поверхностью твердого тела с энергией ³ 50 эВ к числу первичных электронов называют коэффициентом неупругого отражения электронов (КНО) h.
При энергии, близкой к энергии первичных электронов Ep (область с), наблюдается узкий пик, соответствующий упруго отраженным электронам (пик 3 на рис. 5.1). Этот пик связан с электронами, отраженными от поверхности твердого тела без потерь энергии или с очень малыми потерями энергии. Отношение числа этих электронов к числу первичных электронов - коэффициент упругого отражения электронов (КУО), который обычно обозначают R.
Кроме двух достаточно больших по интенсивности пиков истинно вторичных и упруго отраженных электронов, в спектре вторичных электронов на бесструктурном фоне наблюдаются слабо выраженные максимумы. Положения некоторых из них (максимумы 1 на рис. 5.1) не зависят от энергии первичных электронов, другие (максимумы 2) смещаются синхронно с изменением энергии первичных электронов. Пики 1 обусловлены выходом с поверхности оже-электронов. Изучение этой группы вторичных электронов лежит в основе метода электронной оже-спектроскопии (ЭОС). Группа максимумов 2, расположенная вблизи пика упруго отраженных электронов, соответствует первичным электронам, испытавшим дискретные потери энергии при взаимодействии с поверхностью. Эти потери энергии характеризуют вещество поверхности и называются пиками характеристических потерь энергии. Изучение этой группы пиков составляет предмет спектроскопии характеристических потерь энергии электронов (СХПЭЭ). Процессы упругого рассеяния электронов, характеризующиеся пиком упруго отраженных электронов, лежат в основе методов дифракции электронов, позволяющих изучать структуру поверхностных слоев. Наиболее распространенными из этих методов являются дифракция медленных электронов (ДМЭ) и дифракция отраженных быстрых электронов (ДОБЭ).
Количественной характеристикой явления вторичной электронной эмиссии служит коэффициент вторичной электронной эмиссии s. Этот коэффициент численно равен отношению числа всех вторичных электронов к числу первичных электронов. Из приведенных выше определений следует, что
![]() . (5.1)
. (5.1)
5.2. Зависимость коэффициентов вторичной электронной эмиссии и упругого отражения от энергии первичных электронов
Основной характеристикой вторично-эмиссионных свойств вещества является зависимость коэффициента вторичной электронной эмиссии s от энергии первичных электронов Еp. Вид зависимости s(Ep) (рис. 5.2) одинаков для металлов диэлектриков и полупроводников. Для большинства веществ максимальное значение коэффициента вторичной электронной эмиссии sm больше единицы. Это значит, что число эмитированных поверхностью электронов больше, чем число падающих на нее частиц. Исключением являются Be, C, Mg, Al, K, Ca, Sc, Ti, Sr, Cr и Ba, для которых sm не превышает единицы[1].
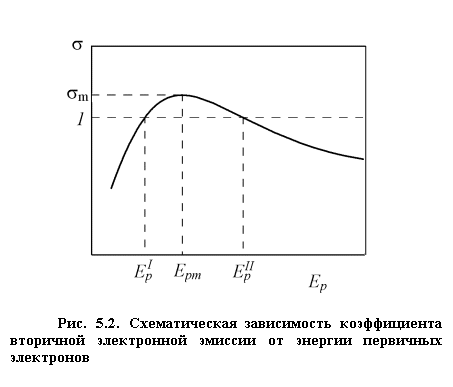 |
Как видно из рис. 5.2 для веществ, у которых sm > 1, коэффициент вторичной электронной эмиссии больше единицы в области энергий первичных электронов Ер, ограниченной первой
Для диэлектрических
материалов максимальное значение коэффициента вторичной электронной эмиссии
значительно превосходит единицу. Известны материалы, в которых sm достигает 25. Столь большое
значение s в сравнении с проводниками
и полупроводниками связано с большой средней длиной свободного пробега
электронов в диэлектрических материалах. Существенное отличие коэффициента
вторичной электронной эмиссии в непроводящих материалах приводит к появлению
поверхностного заряда на образце под действием первичного электронного пучка,
что значительно искажает спектр вторичных электронов и делает невозможным
анализ этого спектра. Значения второй критической энергии![]() для диэлектриков находятся в интервале 2 ¼ 10 кэВ. Выбором
соотвествующей энергии первичных электронов в соответствии с зависимостью s(Ep) для данного образца можно практически исключить
влияние поверхностного заряда [2].
для диэлектриков находятся в интервале 2 ¼ 10 кэВ. Выбором
соотвествующей энергии первичных электронов в соответствии с зависимостью s(Ep) для данного образца можно практически исключить
влияние поверхностного заряда [2].
Для чистых поверхностей металлов 0,5 < sm < 1,8. Значение энергии первичных электронов, при которой наблюдается максимум коэффициента вторичной электронной эмиссии Epm находится в области от 0,2 до 0,9 кэВ. В полупроводниках максимальное значение коэффициента вторичной электронной эмиссии больше 1, но не превышает, как правило 1,5. Максимум s находится в интервале энергий первичных электронов от 0,3 до 0,8 кэВ. Малые значения коэффициента вторичной электронной эмиссии в металлах и полупроводниках связаны с тем, что электроны в этих материалах быстро теряют свою энергию при взаимодействии либо с электронами проводимости (в металлах и вырожденных полупроводниках) либо с валентными электронами (в узкозонных полупроводниках) [1]. В этом случае энергии этих электронов недостаточно для преодоления потенциального барьера у поверхности твердого тела и коэффициент вторичной электронной эмиссии значительно ниже, чем в диэлектриках.
![Подпись:
Рис. 5.3. Интегральные и дифференциальные зависимости коэффициента вторичной электронной эмиссии от энергии первичных электронов для монокристаллической поверхности Si(100) [3]](./vee.files/image013.gif) |
Детальное изучение зависимости коэффициента вторичной электронной эмиссии от энергии первичных электронов позволяет выявить тонкую структуру этой зависимости, проявляющуюся в наличии большого количества изгибов на этой кривой. Тонкая структура проявляется значительно лучше, если экспериментально записывать не интегральную кривую s(Ep), а ее первую производную
Аналогичная тонкая структура
наблюдается и для зависимости коэффициента упругого отражения электронов R от энергии первичных электронов.
Кривая R(Ep) характеризуется
максимумом, всегда расположенным при малых значениях энергии первичных
электронов. Для чистых металлов и элементарных полупроводников максимальное
значение коэффициента упругого отражения электронов находится в пределах 0,1 …
0,35 в области энергий 3 … 10 эВ [1]. С дальнейшим ростом Ep
коэффициент упругого отражения электронов резко уменьшается, причем это
уменьшение имеет немонотонный характер: на ниспадающем участке наблюдаются
изгибы, ступеньки, максимумы. Специальные исследования показали, что
значительная часть этих особенностей, даже для монокристаллов не связана с
дифракционными эффектами. Так же как и в случае коэффициента вторичной
электронной эмиссии более полную и надежную информацию дает дифференциальная
зависимость коэффициента упругого отражения от энергии первичных электронов, а
точнее отрицательная производная ![]() . Максимумы отрицательной производной соответствует энергии
максимумов плотности поглощения электронов, а минимумы – энергии максимумов
плотности упругого отражения электронов. На рис. 5.4 приведены в качестве
примера зависимости R(Ep)
и
. Максимумы отрицательной производной соответствует энергии
максимумов плотности поглощения электронов, а минимумы – энергии максимумов
плотности упругого отражения электронов. На рис. 5.4 приведены в качестве
примера зависимости R(Ep)
и ![]() для монокристалла NaCl, измеренные при 600 K [3].
Сравнение этих зависимостей с энергетической диаграммой NaCl и данными, полученными
другими методами позволили полностью объяснить тонкую структуру зависимости R(Ep). Все энергии максимумов на
кривой
для монокристалла NaCl, измеренные при 600 K [3].
Сравнение этих зависимостей с энергетической диаграммой NaCl и данными, полученными
другими методами позволили полностью объяснить тонкую структуру зависимости R(Ep). Все энергии максимумов на
кривой ![]() совпадают с
пороговыми энергиями возбуждения электронов валентной зоны и верхних уровней в
свободные состояния, в том числе выше уровня вакуума. На рис. 5.4 эти энергии
обозначены стрелками с обозначениями соответствующих энергетических уровней Na и Cl.
Переходы с этих уровней на два уровня, расположенных выше уровня вакуума обозначены
соответственно одной и двумя звездочками. Минимумы отрицательной производной
соответствуют энергиям возбуждения в кристалле NaCl коллективных колебаний валентных электронов –
объемных и поверхностных плазмонов. Энергии объемных и поверхностных плазмонов
с поправкой на электронное сродство материала обозначены на рис. 5.4
соответственно
совпадают с
пороговыми энергиями возбуждения электронов валентной зоны и верхних уровней в
свободные состояния, в том числе выше уровня вакуума. На рис. 5.4 эти энергии
обозначены стрелками с обозначениями соответствующих энергетических уровней Na и Cl.
Переходы с этих уровней на два уровня, расположенных выше уровня вакуума обозначены
соответственно одной и двумя звездочками. Минимумы отрицательной производной
соответствуют энергиям возбуждения в кристалле NaCl коллективных колебаний валентных электронов –
объемных и поверхностных плазмонов. Энергии объемных и поверхностных плазмонов
с поправкой на электронное сродство материала обозначены на рис. 5.4
соответственно ![]() и
и ![]() . Кроме однократных плазменных колебаний в спектре
присутствуют кратные и гибридные моды. Положение экситонного пика поглощения
света в NaCl обозначено Еэкс.
. Кроме однократных плазменных колебаний в спектре
присутствуют кратные и гибридные моды. Положение экситонного пика поглощения
света в NaCl обозначено Еэкс.
Эти результаты показывают, что возбуждение плазменных колебаний электронов в твердом теле может быть связано не только с потерями энергии, но и с резонансным увеличением упругого рассеяния электронов. Строгая теория возникновения резонансов в сечении упругого рассеяния электронов основана на квантовой электродинамике. Физический механизм этого явления связан с возникновением при рассеянии электронов связанной системы из электрона с практически нулевой кинетической энергией и созданного им возбуждения - плазмона, экситона и т.д.[1,3,4].
![Подпись:
Рис. 5.4. Зависимости R(Ep) и (-dR/dEp) для монокристалла NaCl при температуре 600 К [3]:
1 - R(Ep); 2 - (-dR/dEp).](./vee.files/image029.gif) |
Изучение зависимостей коэффициента вторичной электронной эмиссии и коэффициента упругого отражения электронов лежит в основе многочисленных пороговых методов электронной спектроскопии. В литературе можно встретить следующие названия этих методов: спектроскопия упругого отражения электронов малой энергии, спектроскопия потенциала исчезновения, спектроскопия полного тока, интегральная вторично-электронная спектроскопия, низкоэнергетическая вторично-эмиссионная спектроскопия, резонансное упругое рассеяние медленных электронов у порогов неупругих каналов и др. Эти методы позволяют получать информацию не только об элементном составе, но и об энергетической структуре поверхностного слоя твердого тела [4-6].
5.3. Физические основы электронной оже-спектроскопии
В спектре вторичных электронов (рис. 5.1) представлены группы электронов, энергия которых не зависит от энергии первичных электронов, а определяется атомами, испустившими эти электроны. Это, так называемые, оже-электроны. Изучение этой группы электронов лежит в основе одного из самых распространенных в настоящее время методов исследования элементного состава поверхности - электронной оже-спектроскопии (ЭОС) [7,8].
Эмиссия оже-электронов обусловлена оже-эффектом, который был открыт в 1925 г. французским ученым П. Оже (P. Auger). Оже- эффект является следствием ионизации одной из внутренних оболочек атома под действием первичного электронного пучка.
|
Рис. 5.5. Схема генерации оже-электрона. |
На рис. 5.5 показана схема
оже-процесса для атома с полностью заполненными энергетическими уровнями и
валентной зоной. Энергия электронов в атоме отсчитывается от уровня Ферми EF, EV и EC
- энергии потолка валентной зоны и дна зоны проводимости, j - работа выходы электрона. Первичный
электрон с энергией EP создает вакансию на уровне EK атома. Образовавшаяся вакансия через время t ~ 10-14 ¸ 10-16 c.
заполняется электроном с какого-либо верхнего уровня (в примере на рис. 5.5 - с
уровня L1. Избыток энергии
Ek - EL1 может
освободиться в виде характеристического рентгеновского излучения с энергией
кванта ћw =![]() Ek - EL1. Оже-процесс является альтернативным излучению
фотона, избыточная энергия в этом случае передается третьему электрону
находящемуся, например, на уровне L2. Этот электрон испускается в вакуум с
энергией
Ek - EL1. Оже-процесс является альтернативным излучению
фотона, избыточная энергия в этом случае передается третьему электрону
находящемуся, например, на уровне L2. Этот электрон испускается в вакуум с
энергией
![]() (5.2)
(5.2)
и регистрируется как оже-электрон. Слагаемое U в формуле (5.2) учитывает, что в конечном состоянии атом оказывается дважды ионизованным в результате образования вакансий на уровнях L1 и L2. Он учитывает увеличение энергии связи L2-электрона, когда удален L1-электрон и L1-электрона при наличии вакансии на уровне L2. Точное вычисление слагаемого U(L1,L2) затруднено, однако часто используют эмпирическое соотношение, достаточно хорошо согласующееся с экспериментальными результатами:
![]() , (5.3)
, (5.3)
где Z - атомный номер элемента.
Оже-переход, представленный на рис. 5.5, обозначают как KL1L2. Первым записывается обозначение уровня, ионизованного первичным электроном, затем уровня, на котором образовалась вторичная вакансия, и далее уровня, с которого произошло испускание оже-электрона. Электроны, участвующие в оже-процессе могут находиться и на одном и том же уровне, например, KL1L1, L1L2L2 и т. д. Если оже-электрон испускается из валентной зоны, то такой оже-процесс обозначается, например, как KL1V, KVV и т. д. В первом случае в оже-процессе участвует один электрон из валентной зоны, во втором - два.
Для оже-процесса необходимо присутствие в атоме, по крайней мере трех электронов. Поэтому оже-эффект наблюдается у всех элементов, начиная с лития (Z = 3). Однако в металлическом Li из-за наличия валентной зоны оже-эффект наблюдается. Для элементов, находящихся в начале периодической системы элементов (Z £ 14 ) наиболее характерны KLL-переходы, для элементов с 14 < Z £ 40 - переходы LMM, а для элементов с 40 < Z £ 79 - переходы MNN. Вероятность выхода оже-электрона зависит от порядкового номера элемента в периодической системе элементов. Для легких элементов она составляет приблизительно 95%, для элементов с Z > 70 - не превышает 10%. Для K-уровня мышьяка (Z = 33) вероятности выхода оже-электронов и испускания рентгеновских фотонов равны.
Из соотношения (5.2) следует, что энергия оже-электрона определяется энергиями связи соответствующих атомных уровней данного элемента. Таким образом, для каждого элемента существует определенный, характерный только для этого элемента, набор энергий оже-электронов. Этот факт служит основой качественного элементного анализа поверхности методом электронной оже-спектроскопии. По характерному набору пиков в энергетическом спектре оже-электронов идентифицируют элементный состав исследуемого вещества. Для идентификации элементов используют атласы оже-спектров, такие например, как [9], в котором приведены оже-спектры чистых элементов и некоторых соединений, измеренные в стандартных условиях.
Обычно экспериментальные оже-спектры представляют в виде первой производной от кривой распределения вторичных электронов по энергии. Это связано с тем, что доля оже-электронов в общем потоке вторичных электронов незначительна и оже-пики проявляются в виде слабых особенностей в интегральном спектре вторичных электронов (рис. 5.1). Дифференцирование кривой N(E) позволяет избавиться от бесструктурного фона вторичных электронов и точнее определить положение оже-пика. Процедуру дифференцирования можно осуществить численными методами при компьютерной обработке интегральных оже-спектров или с помощью аппаратурных приемов, например методом электрического дифференцирования. Подробнее этот вопрос будет обсуждаться в следующей главе, посвященной экспериментальным методам вторичной электронной спектроскопии.
![Подпись:
Рис. 5.6. Оже-спектр эпитаксиальной пленки g-Fe2O3 [10]](./vee.files/image038.gif) |
В качестве примера качественного элементного анализа из экспериментальных оже-спектров на рис. 5.6 приведен спектр вторичных электронов, эмитированных поверхностью эпитаксиальной пленки g-Fe2O3, который представлен в виде первой производной dN/dE [10]. Пики с энергиями 598, 651 и 703 эВ характерны для LMM оже-переходов в атоме железа [9]. Железу принадлежит и низкоэнергетический спектр в диапазоне энергий 45…50 эВ, связанный с оже-переходами в валентную зону. Серия близко расположенных пиков, основной из которых имеет энергию 510 эВ, принадлежат атомам кислорода. Следует отметить, в электронной оже-спектроскопии принято энергии оже-переходов связывать с отрицательным максимум первой производной кривой распределения электронов по энергии. Истинному же значению энергии оже электронов соответствует нулевое значение на кривой dN/dE.
5.4. Спектроскопия характеристических потерь энергии электронов
Спектроскопия характеристических потерь энергии электронов СХПЭЭ является одним из распространенных методов электронной спектроскопии, в котором исследуются неупруго рассеянные электроны, испытавшие дискретные потери энергии при отражении от поверхности твердого тела или после прохождения тонкой пленки вещества. Потери энергии называются характеристическими, так как энергия потерь не зависит от энергии первичных электронов, а ее величина характерна для данного материала. Пики характеристических потерь энергии электронов располагаются вблизи пика упруго отраженных электронов (рис. 5.1). В отличие от пиков оже-электронов, положения которых не зависят от энергии первичных электронов, положения пиков характеристических потерь определяется Ер. При смещении максимума упруго отраженных электронов при изменении Ер пики характеристических потерь смещаются вместе с ним, оставаясь на одинаковом энергетическом расстоянии от упругого пика.
![Подпись:
Рис. 5.7. Процессы возбуждения валентной зоны и остовных уровней атомов твердого тела [11]](./vee.files/image040.gif) |
Потери энергии электронами связаны с различными процессами на поверхности твердого тела или в тонкой пленке. Это возбуждение в твердом теле квазичастиц фононов и плазмонов, колебания адсорбированных на поверхности атомов и молекул, одночастичные возбуждения валентных электронов (внутризонные и межзонные переходы), ионизация внутренних атомных уровней. Процессы возбуждения валентной зоны и остовных уровней атомов схематически представлены на рис. 5.7 [11]. На этом рисунке EF – энергия Ферми, Eg – ширина запрещенной зоны, EK, EL – энергии связи K и L уровней атома соответственно. Характеристические потери охватывают большой диапазон энергии от нескольких миллиэлектронвольт до, более чем, 103 эВ. Поэтому для реализации этого метода во всем интервале энергии требуются различные экспериментальные методики, чтобы достичь требуемого разрешения как при очень малых, так и при достаточно больших энергиях возбуждения [12]. На рис. 5.8 схематически представлен полный спектр характеристических потерь энергии электронов, на котором обозначены основные механизмы потерь.
![Подпись:
Рис. 5.8. Вид спектра характеристических потерь энергии электронов [12]](./vee.files/image042.gif)
Если для получения спектра характеристических потерь энергии электронов используется первичный пучок электронов с энергией EP < 20 эВ, то метод называется спектроскопия характеристических потерь энергии электронов высокого разрешения (СХПЭЭВР). Первичный пучок электронов в этом случае должен быть очень монохроматичным с шириной линии первичных электронов, измеренной на половине ее высоты, порядка 1 мэВ. Как правило, в СХПЭЭВР исследуют рассеянные отраженные электроны. В некоторых экспериментах изучают угловое распределение электронов, рассеянных поверхностью твердого тела. Этот метод дает большую информацию о дисперсионном соотношении для поверхностных фононов чистых и содержащих адсорбат поверхностях металлов. Широкое применение находит СХПЭЭВР для изучения колебаний адсорбированных на поверхности атомов и молекул, она используется для идентификации адсорбированных частиц и для получения информации о положении адсорбата и геометрии связей.
В обычном методе СХПЭЭ используют первичные электроны с энергией в интервале 100…500 эВ. В этой области энергий возбуждаются поверхностные и объемные плазмоны, внутризонные и межзонные переходы (рис. 5.8). СХПЭЭ при ЕР ~ 100 эВ позволяет изучать электронную структуру чистых поверхностей, тонких покрытий и адсорбатов. В этом случае энергетическое разрешение может быть приблизительно 0,3…0,5 эВ, что не требует дополнительной монохроматизации электронного пучка. Используют луч обычной электронной пушки с термической шириной линии приблизительно 0,3 эВ.
Наиболее интенсивными в спектре характеристических потерь являются потери, связанные с возбуждением объемных и поверхностных плазмонов. Электроны в металлах, которые нейтрализуются неподвижными положительными ионами, достаточно жестко связанными между собой и находящимися в узлах кристаллической решетки, можно рассматривать как особый вид плазмы [13]. Многие явления, характерные для газоразрядной плазмы, такие например, как плазменные или ленгмюровские волны, можно перенести в физику твердого тела. С классической точки зрения плазменные колебания в металлах, квант которого называется плазмоном, представляют собой осцилляции валентных электронов по отношению к положительно заряженным ионам, образующим кристаллическую решетку. Эти осцилляции обусловлены дальнодействием кулоновских сил, благодаря которым на электроны с концентрацией n, смещенным в результате некоторой флуктуации относительно решетки на расстояние x, будет действовать квазиупругая сила [1]:
 , (5.4)
, (5.4)
где Е - электрическое поле, возникающее при смещении электронов относительно ионов; Р = enx – поляризованность; m – масса электрона; е – элементарный заряд; ε0 – электрическая постоянная.
Частота гармонических собственных колебаний электронов газа под действием силы FP, очевидно будет равна
 . (5.5)
. (5.5)
Как видно из соотношения (5.5), частота плазменных колебаний в твердом теле зависит только от плотности электронов, участвующих в этом процессе. Для металлов n @ 1023 см-3, что соответствует wР = 1,8 1016 рад×с-1. Для возбуждения колебаний такой частоты необходимо затратить энергию ћwР » 12 эВ . Измеренные значения энергии плазменных колебаний составляют для магния 10,6 эВ, для алюминия 15,3 эВ [14].
Кроме рассмотренных выше колебаний зарядовой плотности, распространяющихся по всему объему кристалла в виде продольных плазменных волн, которые принято называть объемными плазмонами, в твердом теле существуют также плазменные колебания, локализованные вблизи поверхности. Амплитуда этих колебаний убывает вглубь кристалла. По этой причине эти колебания называют поверхностными плазмонами. Частота поверхностного плазмона wРS связана с частотой объемного плазмона wР следующим соотношением:
 . (5.6)
. (5.6)
Также как и объемные, поверхностные плазменные колебания являются продольными.
![Подпись:
Рис. 5.9. Спектр потерь энергии электронов, отраженных от поверхности алюминия [14]](./vee.files/image050.gif) |
Электроны, обладающие достаточно высокой энергии могут при своем движении в кристалле испытывать многократные потери энергии на возбуждение объемных и поверхностных плазмонов. Вследствие этого в спектрах характеристических потерь наблюдаются пики, соответствующие потерям энергии ћwР, ћwРS, 2ћwР, 2ћwРS, 3ћwР и т.д. На рис. 5.9 в качестве примера приведен спектр характеристических потерь электронов при рассеянии поверхностью чистого алюминия [14]. Пики потерь соответствуют возбуждению одиночных и кратных объемных и поверхностных плазмонов.
В полупроводниках, кроме плазменных колебаний, определяемых концентрацией валентных электронов, возможны плазменные колебания, в которых участвуют лишь электроны зоны проводимости. Частота этих колебаний [1]:
 , (5.7)
, (5.7)
здесь n – концентрация электронов в зоне проводимости; ![]() - эффективная масса электрона;
- эффективная масса электрона; ![]() - относительная диэлектрическая проницаемость полупроводника.
Поскольку концентрация электронов в зоне проводимости значительно меньше этой
величины в валентной зоне, энергия плазменных колебаний электронов зоны
проводимости имеет порядок 0,01 эВ (рис.5.8).
- относительная диэлектрическая проницаемость полупроводника.
Поскольку концентрация электронов в зоне проводимости значительно меньше этой
величины в валентной зоне, энергия плазменных колебаний электронов зоны
проводимости имеет порядок 0,01 эВ (рис.5.8).
В высокоэнергетической области спектра потерь энергии электронов лежат пики, возникающие в результате ионизации остовных уровней атомов первичными электронами. Метод электронной спектроскопии, связанный с исследованием потерь энергии электронов на ионизацию остовных уровней атомов иногда называют ионизационной спектроскопией. Между СХПЭЭ и ионизационной спектроскопией нет принципиального различия. Различаются эти методы лишь количественной величиной потерь энергии электронами.
Спектры характеристических потерь энергии электронов являются потенциальными носителями информации о составе и химическом состоянии элементов на поверхности твердого тела и адсорбированных слоев. Для чистой поверхности кристалла положение пиков объемных и поверхностных плазмонов на электронном спектре является характеристикой вещества, что позволяет идентифицировать отдельные элементы. СХПЭЭ позволяет получать информацию о химических реакциях, происходящих на поверхности при нанесении на нее тонких покрытий или адсорбции атомов другого элемента. Энергия пиков плазменных потерь меняется в зависимости от структурных модификаций одного и того же элемента. Так, например, для различных кристаллических состояний углерода (алмаз, графит, аморфное состояние) энергия объемного плазмона меняется от 33 до 22 эВ. Структура спектра характеристических потерь энергии электронов, положения и интенсивности пиков плазменных потерь будут трансформироваться вследствие изменения за счет химических превращений плотности электронов, участвующих в плазменных колебаниях.
5.5. Фотоэлектронная спектросокпия. Энергетический спектр фотоэлектронов
В основе фотоэлектронной спектроскопии лежит фотоэффект. В этом смысле этот метод не связан с явлением вторичной электронной эмиссии, поскольку электроны в этом случае испускаются поверхностью твердого тела при облучении ее фотонами. В фотоэлектронной спектроскопии может быть использован любой фотон, энергия которого превышает работу выхода электрона (ћw > j). На практике, однако, по крайней мере до последнего времени, практически вся фотоэлектронная спектроскопия охватывала две сравнительно узкие области энергии, определяемые наличием удобных лабораторных источников. Первая область обеспечивается наличием газоразрядных источников на основе инертных газов. Для гелия, например, две основные линии соответствуют фотонам с энергиями 21,2 и 40,8 эВ, лежащими в ультрафиолетовой области спектра. Фотоэлектронная спектроскопия, использующая эти источники называется ультрафиолетовой фотоэлектронной спектроскопией (УФЭС). В УФЭС энергии фотона недостаточно, чтобы вырвать электрон из остовного уровня, поэтому этот метод пригоден для изучения валентных уровней.
Другой широко распространенный источник фотонов относится к области рентгеновского излучения. Наиболее часто источниками фотонов служат Ka линии алюминия (1486,6 эВ) и магния (1253,6 эВ). Это область рентгеновского излучения, поэтому фотоэлектронная спектроскопия, использующая эти источники, называется рентгеновской фотоэлектронной спектроскопией (РФЭС). Достаточно узкие спектральные линии фотоэлектронов, положение которых весьма чувствительно к химическому состоянию элементов на поверхности, делает этот метод весьма удобным для химического анализа. Первоначальное название метода рентгеновской фотоэлектронной спектроскопии, история развития которого насчитывает несколько десятилетий, подчеркивает эту его особенность – электронная спектроскопия для химического анализа (ЭСХА).
В последнее время все более широкое применение в качестве источников фотонов непрерывного спектра в фотоэлектронной спектроскопии находит синхротронное излучение ускорителей заряженных частиц. Эти источники дают спектр от мягкого ультрафиолета до жесткого рентгеновского излучения.
В соответствии с уравнением фотоэффекта
![]() , (5.8)
, (5.8)
где ![]() - энергия фотона, Екин – кинетическая энергия фотоэлектрона, EB – энергия связи электрона в
образце. При изучении твердых тел энергия связи отсчитывается от уровня Ферми.
- энергия фотона, Екин – кинетическая энергия фотоэлектрона, EB – энергия связи электрона в
образце. При изучении твердых тел энергия связи отсчитывается от уровня Ферми.
![Подпись:
Рис. 5.10. Взаимосвязь энергетических характеристик проводящего образца и спектрометра [15].](./vee.files/image062.gif) |
Схема энергетических уровней, имеющих отношение к измерениям энергии связи, показана на рис. 5.10 [15].
Слева
показана энергетическая диаграмма металлического образца. Работа выхода
электрона из образца обозначена как jобр. Справа представлена
аналогичная энергетическая диаграмма для энергоанализатора спектрометра. Работа
выхода электрона из материала спектрометра обозначена как jсп. Энергия связи электрона в
образце, измеренная относительно уровня Ферми ![]() . Кинетическая энергия фотоэлектрона в образце
. Кинетическая энергия фотоэлектрона в образце ![]() , в спектрометре (измеряемая экспериментально кинетическая
энергия фотоэлектрона) -
, в спектрометре (измеряемая экспериментально кинетическая
энергия фотоэлектрона) - ![]() .
.
Поскольку
образец и спектрометр находятся в электрическом контакте, между электронами
этих металлов устанавливается термодинамическое равновесие, в результате
которого их уровни Ферми выравниваются. Именно эта ситуация показана на рис.
5.10. В конечном итоге между образцом и спектрометром устанавливается
контактная разность потенциалов, равная ![]() . Вследствие этого кинетическая энергия фотоэлектрона в
образце и спектрометре будет отличаться. Как видно из рисунка, энергия связи
фотоэлектрона может быть определена из соотношения
. Вследствие этого кинетическая энергия фотоэлектрона в
образце и спектрометре будет отличаться. Как видно из рисунка, энергия связи
фотоэлектрона может быть определена из соотношения
![]() (5.9)
(5.9)
Энергия
фотонов известна, кинетическая энергия фотоэлектрона ![]() регистрируется с
помощью спектрометра, а работа выхода спектрометра легко определяется с помощью
калибровочных экспериментов.
регистрируется с
помощью спектрометра, а работа выхода спектрометра легко определяется с помощью
калибровочных экспериментов.
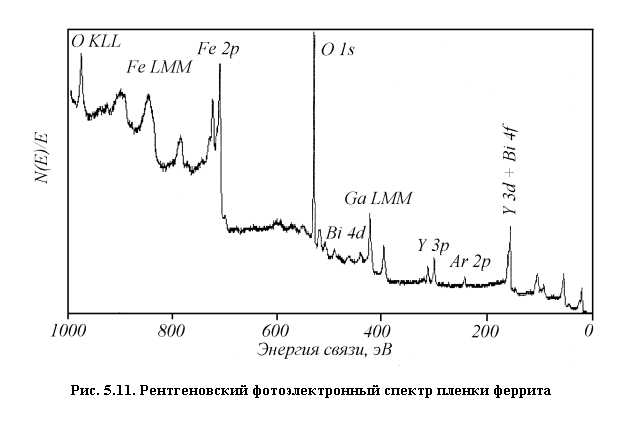
Основные особенности энергетического
спектра фотоэлектронов представлены на рис. 5.11. В качестве источника фотонов
использовалось рентгеновское излучение AlKa. Следует обратить внимание, что в
фотоэлектронных спектрах по оси абсцисс откладывается не кинетическая энергия
электронов, как в электронной оже-спектроскопии, а энергия связи фотоэлектрона,
определенная из приведенного выше соотношения. Другая особенность
фотоэлектронных спектров состоит в том, что бόльшие значения энергии
находятся в начале координатной оси. По вертикальной оси отложена величина ![]() , что делает спектр более наглядным.
, что делает спектр более наглядным.
Приведенный спектр демонстрирует появление типичных острых пиков и растянутых хвостов. Пики соответствуют энергиям характеристических электронов, покидающих твердое тело без процессов, приводящих к потерям энергии. Хвосты со стороны бόльшей энергии связи соответствуют электронам, претерпевшим неупругое рассеяние и потерю энергии на пути из образца и выходящим, поэтому с меньшей кинетической энергией. Уменьшение кинетической энергии фотоэлектронов приводит к кажущемуся увеличению энергии связи (см. уравнение 5.9).
В фотоэлектронной спектроскопии принято обозначать фотоэлектронные линии в спектрах символами атомных орбиталей, которые используются в оптической спектроскопии. В соответствие с этим на рисунке приведены обозначения некоторых фотоэлектронных линий (O1s, Fe2p и т.д.).
После испускания фотоэлектронов с внутренних энергетических уровней атомов на них образуются вакансии. Эти вакансии могут быть заполнены электронами с более высокого уровня в результате оже-процесса. Поэтому в фотоэлектронных спектрах всегда присутствуют пики, соответствующие оже-электронам. Оже линии на спектре, представленном на рис. 5.11 обозначены обычным для оже-спектроскопии методом, в котором используются символы электронных уровней, принятые в рентгеновской спектроскопии (например, оже-линии GaLMM, FeLMM, OKLL). Соотношения между двумя разными обозначениями электронных уровней в атомах представлены в таблице 5.1 [16].
Таблица 5.1.
Соответствие между обозначениями атомных уровней, принятыми в электронной оже-спектроскопии и фотоэлектронной спектроскопии
K |
1s |
N1 |
4s |
|
L1 |
2s |
N2 |
4p1/2 |
|
L2 |
2p1/2 |
N3 |
4p3/2 |
|
L3 |
2p3/2 |
N4 |
4d3/2 |
|
M1 |
3s |
N5 |
4d5/2 |
|
M2 |
3p1/2 |
N6 |
4f5/2 |
|
M3 |
3p3/2 |
N7 |
4f7/2 |
|
M4 |
3d3/2 |
O1 |
5s |
|
M5 |
3d5/2 |
O2,3 |
5p |
Как и в случае фотоэлектронных линий, каждая оже-линия сопровождается низкоэнергетическим хвостом, соответствующему электронам, потерявшим энергию на пути из образца.
Энергия оже линии не зависит от энергии падающего фотона, тогда как энергия фотоэлектронной линии линейно меняется с энергией налетающего фотона.
Фотоэмиссия из электронных состояний p, d и f c ненулевым орбитальным моментом дает спин-орбитальные дублеты. Один из таких дублетов представлен на рис. 5.12 для линии Fe2p. Дублет состоит из двух линий, обозначенных как 2p1/2 и 2p3/2. Индексы 1/2 и 3/2 соответствуют полному результирующему моменту (орбитальный, равный 1 плюс спиновый ±1/2).
 |
Литература
1. Фридрихов С.А., Мовнин С.М. Физические основы электронной техники: Учебник для вузов.- М.: Высшая школа, 1982.- 608 с.
2. Oechsner H. Analysis of electrically non-conducting sample structures with electron and mass spectroscopic methods // Thin Solid Films.- 1999.- Vol. 341, No. 1.- p. 105-108.
3. Бажанова Н.П., Кораблев В.В., Кудинов Ю.А. Актуальные вопросы вторично-эмиссионной спектроскопии. Учебное пособие.- Л.: ЛПИ, 1985.- 88 с.
4. Кухаренко Ю.А., Фридрихов С.А. Резонансное упругое рассеяние медленных электронов в твердых телах вблизи порогов неупругих каналов // Поверхность. Физика, химия, механика.- 1982.- №1.- c. 43-57.
5. Комолов С.А. Интегральная вторично-электронная спектроскопия поверхности.- Л.: Изд-во ЛГУ, 1986.- 180 с.
6. Komolov S.A. Total current spectroscopy of surfaces // Gordon and Breach Science Publishers, 1992.- 317 p.
7. Анализ поверхности методами оже- и рентгеновской фотоэлектронной спектроскопии / Под ред. Д. Бриггса, М.П. Сиха.- М.: Мир, 1987.- 600 с.
8. Вудраф Д., Делчар Т. Современные методы исследования поверхности.- М.: Мир, 1989.- 564 с.
9. Davis L.E., MacDonald N.C. et al., Handbook of Auger Electron Spectroscopy, 2nd edition, Physical Electronics inc., Eden Prarie, Minn, 1976.
10. Parshin A.S., Blekher B.E., Polyakova K.P. Auger-electron Spectrosopy and magnetic properties of Fe-O epitaxial layers // International Conf. on the Physics Transition Metalls, vol.1, Darmstadt, 1992.- p. 550-554.
11. Еловиков С.С. Электронная спектроскопия поверхности и тонких пленок: Учеб. пособие.- М.: Изд-во МГУ, 1992.- 94 с.
12. Luth H. Surfaces and Interfaces of Solids, Second Edition, Springer Verlag, Berlin Heidelberg, 1993. - 487 p.
13. Физические основы, аппаратура и методы электронной спектроскопии: Метод. указания к лабораторным работам по курсу “Физические основы электронной техники”. Сост. Паршин А.С.- Красноярск: САА, 1993. - 28 с.
14. Фельдман Л., Майер Д. Основы анализа поверхности и тонких пленок.- М.: Мир, 1989.- 564.
15. Нефедов В.И., Черепин В.Т. Физические методы исследования поверхности твердых тел.- М.: Наука, 1983.- 296 с.
16. Electron Spectroscopy: Theory, Techniques and Applications.- vol. 4. / Eds. C.R Brundle, and A.D. Baker.- Academic Press, London, New York.- 1981.- 407 p.

