3. ТЕХНОЛОГИЯ ТОНКИХ ПЛЕНОК И МНОГОСЛОЙНЫХ СТРУКТУР
Классическим методом получения чистых поверхностей многих материалов является испарение и конденсация в сверхвысоком вакууме. Тонкие пленки металлов или элементарных полупроводников, получаемые вакуумным испарением обычно поликристаллические или аморфные, т.е. в них невозможна определенная кристаллографическая ориентация поверхности.
Технология многослойных структур должна обеспечивать высокое качество роста материалов слоистых структур и совершенство границ раздела между этими материалами. Только в этом случае могут быть реализованы те потенциальные возможности, заложенные в полупроводниковых сверхрешетках и многослойных магнитных структурах, о которых говорилось выше.
Для получения высококачественных тонких пленок и многослойных структур используют чаще всего механизмы эпитаксиального роста материала пленки на соответствующей монокристаллической подложке. Наибольшее распространение получил метод молекулярно-лучевой эпитаксии (МЛЭ), позволяющий формировать совершенные монокристаллические слои различных материалов в условиях сверхвысокого вакуума. Этот метод успешно применяется для выращивания тонких пленок полупроводников, металлов, диэлектриков, магнитных материалов, высокотемпературных сверхпроводников и многих других веществ. К настоящему времени накоплен достаточно большой объем как теоретических исследований, так и практических работ в этой области, поэтому технология МЛЭ является самым распространенным методом получения полупроводниковых сверхрешеток и многослойных магнитных структур.
В последние годы все большее распространение для выращивания полупроводниковых сверхрешеток приобретает технология роста из газовой фазы с использованием металлоорганических соединений (РГФ МОС) [1]. В этом методе также используется процесс эпитаксиального роста материалов на нагретой подложке при термическом разложении металлорганических соединений. Механизмы роста в методе РГФ МОС изучены не так глубоко, как в МЛЭ, однако этим методом успешно выращивают большинство полупроводниковых соединений AIIIBV, AIIBIV и AIVBVI.
Из методов эпитаксиального роста для получения полупроводниковых сверхрешеток может быть использована и жидкофазная эпитаксия, в которой монокристаллические слои получают из контактирующих с подложкой пересыщенных растворов [2]. С понижением температуры избыточное количество полупроводника осаждается из раствора на подложку, что связано с уменьшением растворимости полупроводникового материала. Наилучшие результаты дает жидкофазная эпитаксия для полупроводниковых соединений типа AIIIBV и их твердых растворов. Многослойные полупроводниковые структуры получают в многокамерных реакторах для жидкофазной эпитаксии путем последовательным созданием контакта с разными расплавами.
Тонкие магнитные пленки и многослойные магнитные структуры могут быть получены различными методами напыления, включая высокочастотное и магнетронное распыление. Эти методы позволяют получать слои практически любого состава. Некоторые исследователи [3] считают, что наилучшие возможности для технологии магнитных многослойных структур дают различные методы электролитического осаждения.
3.1. Молекулярно-лучевая эпитаксия
Молекулярно-лучевая эпитаксия (МЛЭ) по существу является развитием до совершенства технологии вакуумного напыления тонких пленок. Ее отличие от классической технологии вакуумного напыления связано с более высоким уровнем контроля технологического процесса. В методе МЛЭ тонкие монокристаллические слои формируются на нагретой монокристаллической подложке за счет реакций между молекулярными или атомными пучками и поверхностью подложки. Высокая температура подложки способствует миграции атомов по поверхности, в результате которой атомы занимают строго определенные положения. Этим определяется ориентированный рост кристалла формируемой пленки на монокристаллической подложке. Успех процесса эпитаксии зависит от соотношения между параметрами решетки пленки и подложки, правильно выбранных соотношений между интенсивностями падающих пучков и температуры подложки. Когда монокристаллическая пленка растет на подложке, отличающейся от материала пленки, и не вступает с ним в химическое взаимодействие, то такой процесс называется гетероэпитаксией. Когда подложка и пленка по химическому составу не отличаются или незначительно отличаются друг от друга, то процесс называется гомоэпитаксией или автоэпитаксией. Ориентированное наращивание слоев пленки, которая вступает в химическое взаимодействие с веществом подложки, называют хемоэпитаксией. Граница раздела между пленкой и подложкой имеет ту же кристаллическую структуру, что и подложка, но отличается по составу как от материала пленки, так и материала подложки.
По сравнению с другими технологиями, используемых для выращивания тонких пленок и многослойных структур МЛЭ характеризуется, прежде всего малой скоростью роста и относительно низкой температурой роста. К достоинствам этого метода следует отнести возможность резкого прерывания и последующего возобновления поступления на поверхность подложки молекулярных пучков различных материалов, что наиболее важно для формирования многослойных структур с резкими границами между слоями. Получению совершенных эпитаксиальных структур способствует и возможность анализа структуры, состава и морфологии растущих слоев в процессе их формирования методом дифракции отраженных быстрых электронов (ДОБЭ) и электронной оже-спектроскопии (ЭОС).
Упрощенная схема ростовой камеры МЛЭ показана на рис. 3.1. Испарение материалов, осаждаемых в сверхвысоком вакууме на подложку, закрепленную на манипуляторе с нагревательным устройством, осуществляется с помощью эффузионных ячеек (эффузия – медленное истечение газов через малые отверстия). Схема эффузионной ячейки приведена на рис. 3.2. Эффузионная ячейка представляет цилиндрическийе стакан, выполненный из пиролитического нитрида бора или высокочистого графита. Поверх тигля располагаются нагревательная спираль из танталовой проволоки и тепловой экран, изготовленный обычно из танталовой фольги.
Эффузионные ячейки могут работать в области температур до 1400 0С и выдерживать кратковременный нагрев до 1600 0С. Для испарения тугоплавких материалов, которые используются в технологии магнитных тонких пленок и многослойных структур, нагревание испаряемого материала осуществляется электронной бомбардировкой. Температура испаряемого вещества контролируется вольфрам-рениевой термопарой, прижатой к тиглю. Испаритель крепится на отдельном фланце, на котором имеются электрические выводы для питания нагревателя и термопары. Как правило, в одной ростовой камере располагается несколько испарителей, в каждом из которых размещены основные компоненты пленок и материалы легирующих примесей.
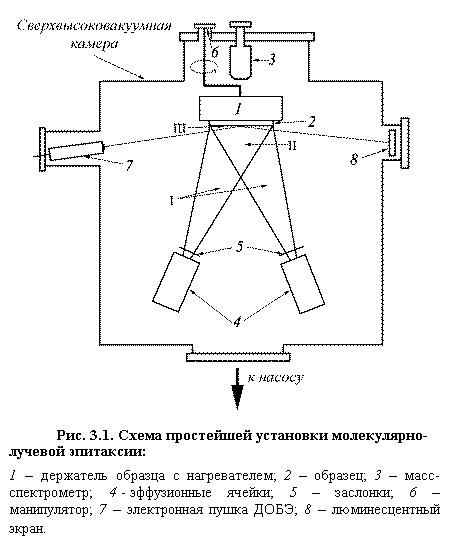 |

Ростовые камеры современных технологических комплексов МЛЭ оборудованы, как
правило, квадрупольным масс-спектрометром для анализа остаточной атмосферы в
камере и контроля элементного состава на всем технологическом процессе. Для
контроля структуры и морфологии формируемых эпитаксиальных структур в камере
роста располагается также дифрактометр отраженных быстрых электронов.
Дифрактометр состоит из электронной пушки, которая формирует хорошо
сфокусированный электронный пучок с энергий 10 – 40 кэВ. Электронный луч падает
на подложку под очень небольшим углом к ее плоскости, рассеянные электронные
волны дают дифракционную картину на люминесцентном экране. Часто ростовые
камеры или в многокамерных комплексах МЛЭ в камере для подготовки и анализа
подложек и эпитаксиальных структур располагаются электронная пушка с
энергоанализатором вторичных электронов и ионная пушка для очистки подложек
ионным травлением и послойного анализа состава эпитаксиальных структур.
Наиболее важная для технологического процесса область ростовой камеры находится между эффузионными ячейками и подложкой (рис. 3.1). Эту область можно разделить на три зоны, которые обозначены на рисунке цифрами I, IIи III. Зона I –зона генерации молекулярных пучков, в этой зоне молекулярные пучки, формируемые каждой из эффузионных ячеек, не пересекаются и не влияют друг на друга. Во второй зоне (зона II – зона смешения испаряемых элементов) молекулярные пучки пересекаются и происходит перемешивание различных компонент. О физических процессах, происходящих в этой зоне известно в настоящее время очень мало. В непосредственной близости от поверхности подложки располагается зона III –зона кристаллизации. В этой зоне происходит эпитаксиальный рост в процессе молекулярно-лучевой эпитаксии. Подробно процессы, происходящие в зоне кристаллизации, будут рассмотрены в следующем разделе.
В промышленности, научно-исследовательских лабораториях широкое распространение в настоящее время получили автоматизированные многомодульные комплексы для молекулярно-лучевой эпитаксии. Модуль – это часть установки, выделенная по функциональным и конструктивным признакам. Модули подразделяются на технологические и вспомогательные. Каждый технологический модуль предназначен для проведения определенного технологического процесса (очистка подложек и анализ состояния их поверхности, эпитаксия полупроводниковых пленок, осаждение металлов и диэлектриков и т.д.). Вспомогательными модулями являются, например, модуль загрузки –выгрузки подложек, модуль предварительной откачки и обезгаживания вакуумных камер и др. Комплекс для МЛЭ в зависимости от технологических задач может быть укомплектован различным количеством специализированных модулей, соединенных между собой шлюзовыми устройствами и системой перемещения подложек и образцов из одного модуля в другой без нарушения вакуума.
Тенденции развития разработок в направлении создания установок для МЛЭ связаны с все более широким применением встроенного аналитического оборудования и автоматизацией технологического процесса, что позволяет улучшить воспроизводимость свойств выращиваемых эпитаксиальных структур и создавать сложные многослойные структуры.
Рассмотрим конкретный пример реализации модульного принципа построения комплекса МЛЭ, разработанного в Институте физики полупроводников СО РАН (г. Новосибирск). На рис. 3.3. представлена упрощенная схема вакуумно-механической системы этого комплекса. Комплекс состоит из трех технологических модулей - модуль анализа и подготовки подложек (ПАП), эпитаксии полупроводниковых соединений (ЭПС) и эпитаксии элементарных полупроводников, металлов и диэлектриков (ЭПМ). Вакуумно-механическая система комплекса включает также модуль загрузки и выгрузки подложек (ЗВП), систему транспорта подложек, систему предварительной откачки и получения сверхвысокого вакуума.
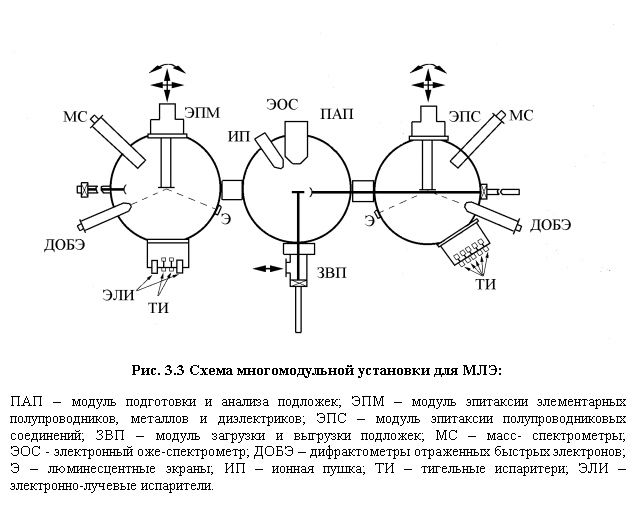
Аналитическое оборудование комплекса представлено в модуле ПАП встроенным
оже-спектрометром и ионной пушкой для очистки подложек и оже-профилирования.
Каждый из блоков ЭПС и ЭПМ содержит масс-спектрометр для контроля остаточных
газов и молекулярных пучков и дифрактометр отраженных быстрых электронов для
контроля структуры и морфологии эпитаксиальных слоев в процессе роста. Помимо
вакуумно-механической системы в комплекс входит автоматизированная система
управления технологическим процессом, позволяющая независимо и одновременно
управлять технологическими процессами как под контролем оператора, так и в
автоматическом режиме.
3.2. Механизмы эпитаксиального роста тонких пленок
Вопросы, связанные с механизмами роста, становятся чрезвычайно важными при создании гетероструктур и многослойных структур, от которых требуется высшая степень однородности состава при толщине менее 100 Å.
Наиболее важные индивидуальные атомные процессы, сопровождающие эпитаксиальный рост следующие:
- адсорбция составляющих атомов или молекул на поверхности подложки;
- поверхностная миграция атомов и диссоциация адсорбированных молекул;
- присоединение атомов к кристаллической решетке подложки или эпитаксиальным слоям, выращенным ранее;
- термическая десорбция атомов или молекул, не внедренных в кристаллическую решетку.
 |
Эти процессы схематически изображены на рис. 3.4 На этом рисунке поверхности подложки и растущего эпитаксиального слоя разделены на «кристаллические участки», с которыми взаимодействуют, поступающие на поверхность из молекулярных источников компоненты. Каждый участок поверхности представляет собой небольшой участок поверхности кристалла и характеризуется индивидуальной химической активностью [1].
Конденсация на подложку нового материала из газовой фазы определяется скоростью столкновения атомов или молекул с подложкой (число частиц, поступающих за единицу времени на единицу площади) [5]:
![]() (3.1)
(3.1)
здесь p – давление паров, М – молекулярный вес частиц, k – постоянная Больцмана и Т – температура источника. Частица, конденсированная из газовой фазы, может сразу же покинуть поверхность подложки или диффундировать по поверхности. Процесс поверхностной диффузии может привести к адсорбции частицы на поверхности подложки или растущей пленки или к процессу поверхностной аггрегации, сопровождающимся образованием на поверхности зародышей новой кристаллической фазы конденсируемого материала. Адсорбция отдельных атомов, как правило, происходит на ступеньках роста или других дефектах. Атомный процесс взаимодиффузии, при котором атомы пленки и подложки обмениваются местами, играют важную роль в процессе эпитаксиального роста. В результате этого процесса граница между подложкой и растущей пленкой становится более гладкой.
Процессы на поверхности, сопровождающие эпитаксиальный рост при МЛЭ могут быть описаны количественно. Каждый из индивидуальных атомных процессов, рассмотренных выше, характеризуется собственной энергией активации и может быть в первом приближении представлен экспоненциальным законом. Скорость десорбции, например
 ,
,
где Ed – энергия активации процесса десорбции, Ts– температура подложки.
На феноменологическом уровне различают три основные типа роста тонких эпитаксиальных пленок [4]:
1.
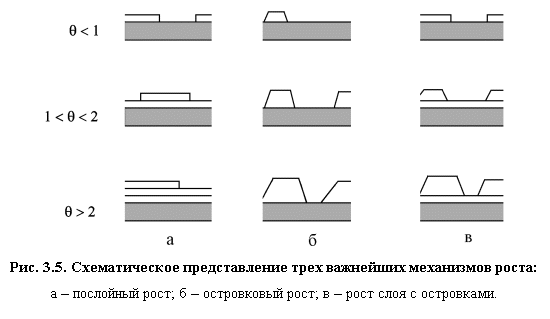 |
Послойныйрост (layer-by-layer growth). При этом механизме роста каждый последующий слой пленки начинает формироваться только после полного завершения роста предыдущего слоя. Этот механизм роста называют также ростом Франка-ван дер Мерве (Frank-van der Merve, FM). Послойный рост имеет место, когда взаимодействие между подложкой и слоем атомов значительно больше, чем между ближайшими атомами в слое. Схематическое представление послойного роста пленки для различной степени покрытия q (в долях монослоев ML) показано на рис. 3.5,а.
2. Островковый рост или рост Вольмера-Вебера (island growth, Vollmer-Weber, VW). Этот механизм является полной противоположностью послойному росту. Условием его реализации является преобладание взаимодействия между ближайшими атомами над взаимодействием этих атомов с подложкой. При островковом механизме роста вещество с самого начала оседает на поверхности в виде многослойных конгломератов атомов.
3. Промежуточным между этими двумя механизмами является рост Странски-Крастанова (Stransky-Krastanov, SK, layer-plus-islandgrows), при котором первый слой полностью покрывает поверхность подложки, а на нем происходит рост трехмерных островков пленки. К этому механизму могут приводит многие факторы, в частности достаточно большое несоответствие между параметрами кристаллических решеток пленки и подложки.
Схематические иллюстрации островкового механизма роста и роста Странски-Крастанова приведены на рис. 3.5,б и 3.5,в соответственно.
Условие,разграничивающее реализацию того или иного механизма роста, можно получить из анализа соотношений между коэффициентами поверхностного натяжения между подложкой и вакуумом sS, между пленкой и вакуумом sFи между подложкой и пленкой sS/F (рис. 3.6) [5]. Коэффициент поверхностного натяжения поверхности равен свободной энергии единицы поверхности. Соответственно эти коэффициенты определяют силы поверхностного натяжения, действующие на единицу элемента длины границы раздела. Согласно этому определению сила dF, действующая на бесконечно малый элемент dl границы раздела двух сред
 |
Из условия равновесия для любого элемента длины линии соприкосновения подложки, трехмерного островка пленки и вакуума (рис. 3.6) получим
![]() , (3.2)
, (3.2)
где j - краевой угол, т.е. угол, образованный касательной к поверхности островка пленки и поверхностью подложки.
Если краевой угол равен нулю, то островок “растекается” тонким слоем по поверхности подложки, что соответствует послойному механизму роста. Это условие приводит к следующему соотношению между коэффициентами поверхностного натяжения:
![]() , послойный
рост (3.3)
, послойный
рост (3.3)
Если
![]() , реализуется механизм роста островков, условие которого
, реализуется механизм роста островков, условие которого
![]() рост
островков (3.4)
рост
островков (3.4)
Для более полного вывода условий, при которых реализуется тот или иной механизм роста, необходимо учесть влияние на условие равновесия между формируемой пленкой и подложкой газовой фазы в области роста пленки.
Часто в литературе рассматривают еще один механизм роста – статистическое осаждение [4]. При этом механизме роста пленки атомы осаждаемого вещества располагаются на поверхности согласно распределению Пуассона так, как если бы их бросали случайно и они просто прилипали бы на месте падения.
3.3. Рост из газовой фазы с использованием металлоорганических соединений
Методы газофазной эпитаксии, отличающиеся простотой и воспроизводимостью химических процессов осаждения тонких пленок достаточно интенсивно используется для получения пленок полупроводниковых материалов, но может быть также применен для производства пленок металлов и диэлектриков [9]. В основе этих методов лежат процессы переноса осаждаемых материалов в виде летучих соединений к поверхности подложки, на которой происходит разложение этих соединений с выделением необходимо продукта. Из методов газофазной эпитаксии в производстве промышленного кремния широкое применение получил метод восстановления кремния в атмосфере водорода из его тетрахлорида (SiCl4):
![]() . (3.5)
. (3.5)
В этом же реакторе производят легирование эпитаксиальных слоев кремния, используя источники жидких или газообразных веществ, содержащих легирующие примеси. Например, для получения эпитаксиального слоя n-типа используют вещества, содержащие фосфор: PCl3, PBr3, PH3 и др. Слой p-типа получают легированимем кремния бором из его соединений, например, BBr3, B2H2 и др.
В последнее десятилетие, когда возник интерес к массовому производству приборов с субмикронными слоями (полевых транзисторов, лазеров, фотоприемников, солнечных элементов и др.) из методов газофазной эпитаксии наиболее интенсивно развивается метод роста из газовой фазы с использованием металлоорганических соединений (РГФ МОС). Этот метод находит все более широкое применение в технологии полупроводниковых структур, в том числе и полупроводниковых сверхрешеток [1]. В различных источниках для описания этой технологии используется разные названия: «металлоорганическая газофазная эпитаксия», «органометаллическая газофазная эпитаксия», «металлалкильная газофазная эпитаксия». Название «рост из газовой фазы с использованием металлоорганических соединений» является наиболее общим, так как подчеркивает возможность роста неэпитаксиальных (поликристаллических или аморфных) пленок. В этом методе рост эпитаксиального, поликристаллического или аморфного слоя осуществляется при термическом разложении ( пиролизе) газообразных металлогранических соединений и последующей химической реакции между возникающими компонентами на нагретой подложке. Термин «металлорганика» обозначает вещества, содержащие металл-углеродные или металл-кислород-углеродные связи, а также соединения металлов с органическими молекулами. Впервые в 1968 г. методом РГФ МОС были получены пленки арсенида галлия [6].
Химическая реакция, с помощью которой были получены пленки GaAs, может быть записана в виде:
![]() . (3.6)
. (3.6)
Разложение газовой смеси триметилгаллия (CH3)3Gaи гидрида мышьяка (арсина) AsH3 происходит при температуре 700 0С в атмосфере водорода Н2.
С помощью РГФ МОС выращивают большинство полупроводниковых соединений AIIIBV, AIIBVI и AIVBVI, а также многие важные тройные и четверные соединения AIIIBV. Например, соединение AlxGa1-xAs обычно выращивают, используя следующий процесс:
![]() (3.7)
(3.7)
![Подпись:
Рис. 3.7. Схематическое изображение вертикального реактора для РГФ МОС [1]
1 – кварцевый реактор; 2 – высокочастотный нагреватель; 3 – подложка; 4 – графитовый держатель; 5 – источники металлорганических соединений; 6 – датчики потока; 7 – вентили;](./Techn_i.files/image034.gif) |
Реакции типа (3.6) и (3.7) проводят в специальных реакторах для РГФ МОС. Схема одного из подобных реакторов приведена на рис. 3.7. Подложка 3, на которой происходит кристаллизация требуемого соединения помещена на графитовом держателе 4 внутри кварцевого реактора 1. Реакция происходит при атмосферном или при пониженном (приблизительно до 10 торр) давлении. Температура пиролиза 600 – 800 0С обеспечивается радиочастотным нагревом с частотой несколько сотен килогерц (высокочастотный нагреватель 2). Такая система нагрева создает высокую температуру вблизи поверхности подложки, так как нагревается только графитовый держатель, в то время как стенки реакционной камеры остаются холодными. В этом случае полупроводниковая пленка образуется только на поверхности подложки, а реакция на стенках реактора не наступает.
Металлоорганические соединения (на рис. 3.7. – диэтилцинк DEZn, триметил галлий TMGa, триметилалюминий TMAl) доставляются в зону реакции с помощью газа носителя H2.
Многослойные, многокомпонентные структуры методом РГФ МОС могут быть выращены в едином ростовом цикле. Для этой цели в реакторах предусмотрена возможность подключения нескольких металлорганических и гидритных источников. Использование автоматизированного управления процессом роста в методе РГФ МОС позволяет создавать полупроводниковые сверхрешетки с толщиной отдельных слоев до
1,5 нм [1,7], причем изменение состава на гетеропереходе происходит практически на толщине одного атомного слоя. [1,8].
К достоинствам метода РГФ МОС следует отнести возможность создания однородных эпитаксиальных структур большой площади на установках, аналогичных тем, которые используются в производстве промышленного эпитаксиального кремния.
3.4. Получение многослойных магнитных структур методом электролитического осаждения
Метод электролитического осаждения – наиболее старый метод получения тонкопленочных структур металлов. В технологии производства изделий электронной техники этот метод для осаждения серебра, золота, меди и никеля, хрома, свинца, платины, олова, цинка и ряда других металлов [9]. Достаточно давно этот метод применяется для получения тонких пленок ферромагнитных металлов и их сплавов [10, 11]. Технологический процесс происходит в электролитической ванне, упрощенная схема которой представлена на рис. 3.8. В качестве электролита такой ванны используются водные растворы солей осаждаемого металла. Например, для осаждения пленок никеля электролит содержит растворы сульфата никеля и хлористого аммония. Катионы, которые нужно осадить, могут присутствовать в электролите в виде свободных ионов или комплексов. Анод электролитической ванны соединен с положительным полюсом источника постоянного тока, катод, являющийся подложкой осаждаемой пленки – с отрицательным полюсом.
При пропускании через электролитическую ванну электрического тока, величина которого контролируется амперметром, катионы, в числе которых и катионы осаждаемого металла, движутся к катоду (в нашем примере Ni2+ и NH4+), анионы (SO42- и Cl-) – в противоположном направлении.
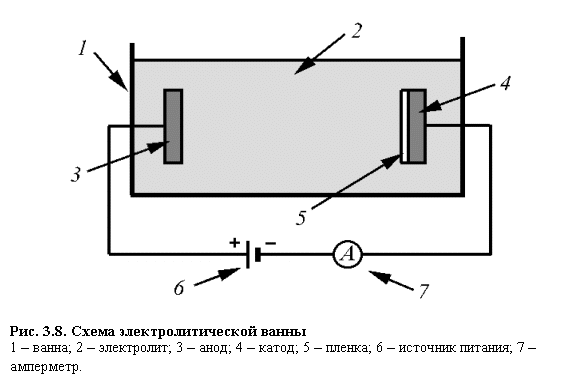 |
Согласно законам электролиза Фарадея скорость осаждения металла на катоде определяется плотностью электрического тока j , прошедшего через электролитическую ванну:
 , (3.8)
, (3.8)
где h - выход по току; r - плотность осажденного металла; E – напряженность электрического поля; F – число Фарадея.
На рис. 3.9. схематически показана вольтамперная характеристика процесса электролиза. При абсолютном значении потенциала катода j выше некоторой величины jН процесс электролитического осаждения достигает насыщения. С другой стороны при j < jР осаждение металлической пленки на катоде прекращается и наблюдается даже растворение катода. В этом режиме электролитическую ванну можно использовать для предварительной очистки подложки. Таким образом, технологический режим электролитического осаждения ограничен значениями потенциала катода от jН доjР.

На процесс электролитического осаждения металлической пленки существенное
влияние оказывают состав электролита, кислотность электролитической ванны,
плотность электрического тока, температура подложки и т.д. Технологические
режимы, как правило, подбираются опытным путем из условия наилучшего протекания
процесса электролитического осаждения. Для улучшения этого процесса в
электролит добавляют различные присадки, которые не влияют на состав осаждаемой
пленки, а для улучшения самого процесса электролитического осаждения. Например,
невосстанавливающие катионы калия и кальция в электролите увеличивают его
электропроводность. Добавки различных неорганических соединений уменьшают
зависимость процесса от кислотности электролита.
Наиболее простой способ получения многослойных структур металлов возможен при многократном переносе подложки из одного электролита в другой, в каждом из которых осаждается пленка соответствующего металла. Таким способом еще в 1921 г. были получены пленки из чередующихся слоев меди и никеля. В современных методах электролитического осаждения многослойных структур металлов используется тот факт, что у многих металлов существенно отличаются их равновесные потенциалы восстановления [3]. Так, например, немагнитные металлы Cu, Ag, Au могут осаждаться при очень малых (иногда даже положительных) потенциалах катода, магнитные элементы группы железа эффективно осаждаются при достаточно высоких отрицательных потенциалах катода. Разница между ними может составлять 600 мВ и более [3, 12]. Это обстоятельство позволяет при использовании импульсного напряжения на катоде получать многослойные структуры из одного и того же электролита.
![Подпись:
Рис. 3.10. Совмещенная диаграмма Пюрбаха меди и никеля [12]](./Techn_i.files/image042.gif) |
На рис. 3.10 приведены совмещенные диаграммы Пюрбаха меди и никеля [3,12]. Из них видно, что при потенциале катода в области I на катоде будет осаждаться только медь. Если потенциал находится в области II, то будут осаждаться как медь, так и никель. В технологии электролитического осаждения многослойных структур из одного электролита используется электролит, содержащий соли обоих металлов. Предельная плотность тока осаждения каждого элемента в этом случае зависит от его концентрации в электролите. На рис. 3.11 в качестве примера приведена зависимость плотности тока осаждения меди от потенциала катода для электролитов с разным содержанием ионов меди. Из солей металлов в состав электролита входили никель сернокислый (NiSO4), никель хлористый (NiCl2) и медь сернокислая [12]. Кривая 1 соответствует простому электролиту, содержащему только ионы никеля с потенциалом насыщения, соответствующего точке В (сравнить с данными рис. 3.9). По мере увеличения в электролите ионов меди в вольтамперной зависимости процесса электролитического осаждения наблюдается вторая область насыщения (точка А), которая определяется предельной плотностью тока осаждения меди. при значительно меньших потенциалах на катоде. Отсюда следует, что при потенциале катода 100…500 мВ (точка А, рис.3.11) на нем будет осаждаться чистая медь, так как этого потенциала еще недостаточно для осаждения никеля. Если теперь резко поднять потенциал катода до величины приблизительно 1000 мВ (точка В на рис. 3.11), то выделяться будет практически только никель, так как скорость осаждения меди остается малой в сравнении со скоростью осаждения никеля.
 |
Для получения многослойных структур необходимо на катод электролитической ванны периодически подавать импульсы напряжения разной амплитуды и длительности, в течение которых на катоде будет осаждаться соответствующий металл. В зависимости от режимов подачи импульсов различают потенциостатическое и гальваностатическое импульсное электролитическое осаждение. При гальваностатическом осаждении на катоде поддерживается постоянной в течение каждого импульса плотность тока. Так, при получении Cu-Ni многослойных структур [12] плотность тока при осаждении слоя меди составляла 1,5 мА/см2, в то время как при осаждении слоя никеля плотность тока поддерживалась равной 100 мА/см2. В потенциостатическом режиме постоянными на катоде поддерживались напряжения: -400 мВ для меди и -1000 мВ для никеля. При длительности импульсов 5,5 с и 0,2 с при осаждении Cu и Ni соответственно формировались слои этих металлов одинаковой толщины по 100 Å.
Потенциостатический режим осаждения в большинстве случаев позволяет получать более резкую границу между слоями в магнитных многослойных структурах. При оптимальном выборе режимов электролитического осаждения содержание магнитного элемента в немагнитном и наоборот может не превышать 0,5…0,1 % [3].
Литература
Херман М. Полупроводниковые сверхрешетки: Пер. с англ.- М.: Мир, 1989.- 240 с.
Уфимцев В.Б., Акчурин Р.Х. Физико-химические основы жидкофазной эпитаксии.- М.: Металлургия, 1983.- с.
Федосюк В.М., Шелег М.У., Касютич О.И. Многослойные магнитные структуры // Зарубежная радиоэлектроника.- 1990.- № 5.- С. 88 – 97.
Фельдман Л., Майер Д. Основы анализа поверхности и тонких пленок. - М: Мир, 1989. - 344 с.
Luth H. Surface and Interfaces of Solids. Springer Series in Surface Science 15. – Springer-Verlag, Berlin, Heidelberg, 1993. – 356 p.
Manasevit H.M. …..// Appl. Phys. Lett. – 1968.- Vol.12, No. .- P. 156 - .
Griffits R. J. M., Chew N. G., Cullis A.G., Joyce G.C. // Electronics Lett.- 1983.- Vol. 19, No. .- P.988 –
Leys M.R., van der Opdorn C., Viegeles M.P.A. Talen-van der Mhen H.J.
// J. Cryst. Growth.- 1984.- Vol. 68, No. .- P. 431 - .
Вакуумное оборудование тонкопленочной технологии производства изделий электронной техники: Учебник для студентов специальности «Электронное машиностроение» ./ Н.В. Василенко, Е.Н. Ивашов, Л.К. Ковалев и др.; Под ред. Проф. Л.К. Ковалева, Н.В. Василенко.: В 2 т. Т.1.- Красноярск: кн. изд-во Сиб. аэрокосм. акад., 1995. – 256 с.
Суху Р. Магнитные тонкие пленки.- М.: Мир, 1967.- 422 с.
Праттон М. Тонкие ферромагнитные пленки.- Л.: Судостроение, 1967.- 266 с.
Bennet L. H., Lashmore D.S., Dariel M.P. et al. Magnetic properties of electrodepositied copper-nikel composition-modulated alloys // Journ. Magn. And Magn. Materials.- 1987.- Vol. 67, No. 1.- P. 239 – 245.