РЕНТГЕНОВСКАЯ ДИФРАКЦИЯ.
ВВЕДЕНИЕ
Физические свойства твердых тел определяются их внутренним микроскопическим строением. Это строение обусловлено взаимным расположением структурных частиц вещества (атомов, молекул, ионов) из которых состоит твердое тело. В зависимости от степени упорядоченности атомов твердые тела разбиваются на два типа: аморфные и кристаллические. Для аморфного состояния характерна упорядоченность на расстояниях сравнимых с межатомными. В кристаллах правильное чередование атомов наблюдается на неограниченно больших расстояниях, т.е. наряду с ближним порядком, существует и дальний порядок. Основным признаком дальнего порядка является симметрия кристалла. В реальных кристаллических телах всегда существуют в большей или меньшей степени микро- или макро-нарушения порядка, которые, так или иначе, сказываются на его свойствах.
Упорядоченное строение кристаллических твердых тел впервые было доказано в 1912 году М. Лауэ с помощью дифракции рентгеновских лучей. Кристаллы являются природными дифракционными решетками для этих лучей, поскольку длины волн рентгеновских лучей соизмеримы с межатомными расстояниями в кристаллических структурах. Излучения с большей длиной волны не могут выявить деталей структуры на атомном уровне, а коротковолновое излучение дифрагирует, отклоняясь лишь на очень малые углы, что весьма неудобно. В настоящее время существуют несколько дифракционных методов исследования атомного строения вещества: рентгено-, электроно- и нейтронографический методы. Различие этих методов вытекает из особенностей взаимодействия данных излучений с веществом. Общим у этих трех методов является то, что они опираются на общую теорию упругого рассеяния.
УСЛОВИЯ НАБЛЮДЕНИЯ ДИФРАКЦИОННЫХ МАКСИМУМОВ
Для того, чтобы волны, рассеянные семейством параллельных плоскостей кристалла дали максимум интенсивности необходимо выполнение следующего соотношения между межплоскостным расстояниемd, углом падения рентгеновских волн на данную кристаллографическую плоскость и длиной волны рентгеновского излучения l:
2d sinθ= n λ. (1)
здесь n – любое целое число (порядок отражения).
Это равенство выражает основной закон дифракции рентгеновских лучей в кристаллах и называется условием Брэгга-Вульфа.
Это условие имеет простую физическую интерпретацию: рентгеновские волны, рассеянные соседними атомными плоскостями кристалла будут при интерференции усиливаться в том случае, когда разность хода между ними равна целому числу длин волн λ.
Брэгговское отражение имеет место только при длинах волн λ ≤ 2d. С уменьшением λуменьшается и угол θ.
Часто для нахождения условий усиления рассеянных кристаллической решеткой волн используют эквивалентные уравнению Брэгга-Вульфа условия Лауэ. Для вывода условий Лауэ необходимо рассмотреть результат интерференции волн, рассеянных от соседних атомов кристаллической решетки. Для одномерной цепочки атомов с межатомным расстоянием а в случае перпендикулярного падения первичных волн относительно линии атомов условие усиления запишется в виде:
![]() , (2)
, (2)
здесь m – любое целое число, j - угол между линией атомов и направлением рассеяния.
Для трехмерной решетки атомов необходимо одновременное выполнение трех условий:
![]() ,
,
![]() , (3)
, (3)
![]() ,
,
В этих формулах a, b, c– параметры решетки; ja, jb,jc– углы рассеяния вдоль соответствующих кристаллографических направлений; h, k, l – любые целые числа, определяющие порядок спектра.
АМПЛИТУДЫ РАССЕЯННЫХ ВОЛН.
Условия (2) и (3) дают возможность определить только направления, при которых происходит усиление рентгеновских волн, рассеянных атомными плоскостями или атомами кристалла. Интенсивность дифрагированного луча определяется электронной плотностью атомов, расположением атомов в элементарной ячейке, тепловыми колебаниями атомов кристаллической решетки и т.д.
Наиболее простой метод расчета интенсивности дифракционных максимумов, предложенный Лауэ, состоит в суммировании вкладов от элементарных волн, рассеянных от каждого элемента кристалла.
Выражение для суммарного рассеяния в направлении к точке наблюдения от решетки точечных атомов можно получить, суммируя амплитуды рассеянных волн по всем точкам решетки. Интересующая нас величина является суммой фазовых множителей:
![]() (3)
(3)
где m, n, p - целые числа, принимающие значения от 0 до Н (в этом случае кристалл содержит Н3 примитивных ячеек), ρmnp - вектор, который проводится из начала системы координат, и принимает все возможные значения в соответствии с выражением:
ρmnp = ma+nb+pc;
a, bи c- единичные векторы, q- вектор рассеяния.
Пусть в кристалле конечных размеров, имеющем форму параллелепипеда, одинаковые точечные центры рассеяния расположены в каждом узле решетки ρmnp . Из (3) видно, что величина суммарного излучения пропорциональна
![]()
![]() (4)
(4)
Величину I называют амплитудой рассеяния
Сумма, взятая по узлам решетки максимальна когда:
![]() (целое число) (5)
(целое число) (5)
для всех узлов решетки, т. к. каждый член, имеющий форму exp(-iρmnp q), равен единице. Когда q удовлетворяет выражению (5), сумма для амплитуды рассеяния в пределах кристалла, имеющего Н3узлов решетки, дает:
Imax= Н3
Отклонение значения qот величины, удовлетворяющей соотношению (5), будет значительно уменьшать величину суммы в (4).
Величина q удовлетворяет условию дифракции (5), если выполняются одновременно следующие три условия для целых чисел h,k ,l:
a×q=2πh, b×q=2πk, c×q=2π l (6)
Эти уравнения называются уравнениями дифракции Лауэ.
Также как и формула Брэгга-Вульфа (1), уравнения Лауэ представляют собой необходимые условия дифракции. Если элементарная кристаллическая ячейка содержит более одного атома, то эти уравнения не являются достаточными условиями, так как необходимо также, чтобы структурный фактор (определение его дано ниже) не был равен нулю. Если он равен нулю, то амплитуда рассеянной волны будет равна нулю.
При рассеянии рентгеновских лучей основную роль играют электроны атомов, т.к. масса ядра слишком велика, чтобы «почувствовать» рентгеновский квант. Интенсивность различных отражений зависит от состава элементарной ячейки, т.е. от числа и расположения атомов в ячейке и от распределения их электронной плотности. Наиболее типичным случаем рассеяния является рассеяние на распределении электронной плотности по всему кристаллу. Если рассеяние на элементе объема кристалла dV пропорционально локальной электронной плотности (концентрации электронов) n(ρ), то амплитуда рассеяния пропорциональна интегралу:
![]() (7)
(7)
Как известно, электроны в атоме не концентрируются вблизи ядра, а располагаются в его окрестности.
Распределение электронов в кристалле можно описать с помощью суперпозиции функций электронной
плотности Cj,каждая из которых связана с отдельным атомом. Так, функция
![]() (8)
(8)
определяет концентрацию электронов в точке ρ вблизи j-го атома ячейки mnp. Допустим, что каждая ячейка состоит из s атомов. Тогда полная электронная плотность n(ρ) в кристалле может быть записана в виде суммы:
 (9)
(9)
где первое суммирование (j=1,…, s) производится по всем атомам базиса, а второе по всем узлам решетки, число которых, определенное выше равно Н3.
В соответствии с (7) общую амплитуду рассеяния в кристалле для вектора рассеяния q можно записать:
![]() (10)
(10)
Вклад в I единичного члена Cj(ρ- ρi- ρmnp)в выражении (10) равен:
![]() , (11)
, (11)
где ![]() а величина
а величина
![]() (12)
(12)
называется атомным фактором рассеяния или форм-фактором. Величина fj является мерой рассеивающей способности j-го атома элементарной ячейки. Она зависит от числа и распределения электронов атома, а также от длины волны и угла рассеяния излучения, вследствие интерференционных эффектов, обусловленных конечным размером атомов.
Выражение для амплитуды рассеяния можно теперь записать так:
![]() (13)
(13)
или
![]() (14)
(14)
При записи последнего
выражения использовали полученный выше результат [см. форм. (5)], что ![]() когда q равен вектору обратной решетки
G . Сумма:
когда q равен вектору обратной решетки
G . Сумма:
![]() (15)
(15)
называется структурным фактором базиса. Учитывая, что для некоторого отражения (hkl):
![]()
структурный фактор для указанного отражения можно записать:
![]() (16)
(16)
Структурный фактор не обязательно должен быть вещественной величиной; в значение интенсивности рассеянной волны входит FF*, Где F*-величина, комплексно-сопряженная F.
ДИФРАКЦИЯ НА СВЕРХРЕШЕТКАХ.
Дифракция рентгеновского излучения хорошо подходит для изучения структуры сверхрешеток. Это неразрушающая методика и позволяет получать информацию на атомном уровне. Профиль рентгеновской дифракции обычно разделяется на 2 области - низкоугловую (<15˚)и высокоугловую(>15˚). Низкоугловая область возникает из-за дополнительного рассеяния слоями сверхрешетки, состоящих из различных химических элементов (материалов). В этой области позиции пиков определяются выражением:
 (17)
(17)
где θ - угол положения пика, n-порядок отражения, λх- длина волны рентгеновского излучения, ![]() - реальная часть
среднего показателя преломления сверхрешетки,
- реальная часть
среднего показателя преломления сверхрешетки, ![]() - расстояние между
одинаковыми слоями сверхрешетки. Когда слои очень толсты, когда один из
материалов аморфен или если параметры решеток слоев сильно различаются, то
положения пиков соответствуют положениям пиков составных материалов
сверхрешетки.
- расстояние между
одинаковыми слоями сверхрешетки. Когда слои очень толсты, когда один из
материалов аморфен или если параметры решеток слоев сильно различаются, то
положения пиков соответствуют положениям пиков составных материалов
сверхрешетки.
Для удобства, высокоугловые
пики определяются относительно среднего значения постоянной решетки ![]() :
:
 (18)
(18)
где n-целое число, указывающее номер (порядок) саттелитного пика вокруг
основного Брэгговского пика и ![]() где NA и NB – числа атомных плоскостей материала А и В в одном двойном
слое.
где NA и NB – числа атомных плоскостей материала А и В в одном двойном
слое.
На интенсивность и вид высокоугловых пиков рентгеновского рассеяния значительно влияет беспорядок, присутствующий в структуре сверхрешетки. Различают дискретный и непрерывный совокупный беспорядок. Дискретный беспорядок толщины предполагает, что толщины изменяются целым числом атомных плоскостей. Непрерывный беспорядок относится к структурным параметрам,
На интенсивность и вид высокоугловых пиков рентгеновского рассеяния значительно влияет беспорядок, присутствующий в структуре сверхрешетки. Различают дискретный и непрерывный совокупный беспорядок.
Дискретный порядок толщины предполагает, что толщины изменяются целым числом атомных плоскостей. Непрерывный беспорядок относится к структурным параметрам, которые изменяются непрерывным образом подобно толщине аморфного слоя. Непрерывный беспорядок может быть разделен на два типа: внутрислойный и межслойный беспорядок.
Внутрислойный беспорядок относится к качеству упорядочения атомов в пределах одного слоя. Кристаллический слой имеет высокую степень внутрислойного порядка, в то время как аморфный слой не упорядочен.
Межслойный беспорядок относится к отклонениям в периодичности слоев в направлении роста, следующим из изменений толщины слоя и беспорядка «прослойки».
Общая модель сверхрешетки состоит из «пакета», содержащего М двойных слоев материалов А и В, показанного на рис. 1. Слои характеризуются структурными факторами FAj и FBj и толщинами tAj и tBj, материалов А и В, в j-ом двойном слое. Эта одномерная модель сверхрешетки явно включает только беспорядок промежуточного слоя.
Одномерный структурный фактор для сверхрешетки, состоящей из М двойных слоев с совокупными колебаниями толщины слоя:
 (19)
(19)
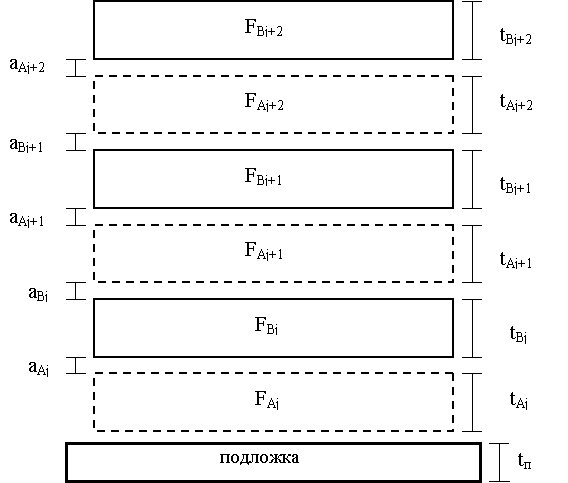 |
Рис.1. Модель сверхрешетки, состоящей из материалов А и В, с толщинами tAj, tBj и структурными факторами FAj,FBj. Слои отделены межслойными расстояниями aAjи aBj.
где  и
и ![]() - вектор рассеяния.
- вектор рассеяния.
Для сверхрешеток интенсивность рассеяния дается следующим выражением:
![]() , (20)
, (20)
где
![]() - величина,
комплексно сопряженная FSL(q).
- величина,
комплексно сопряженная FSL(q).
Уравнение (19) может быть расширенно для получения структурного фактора двумерной системы. Это делается для того, чтобы включить межплоскостное усреднение системы, показанной на рис.2.
Структурный фактор L колонок с М двойными слоями, при условии, что каждая колонка является статистически независимой записывается как:
 (21)
(21)
![]()
где  и tS,k – отклонение толщины подложки от среднего значения
для к-ой колонки.
и tS,k – отклонение толщины подложки от среднего значения
для к-ой колонки.
Чтобы записать структурный фактор сверхрешетки FSL(q) в развернутом виде необходимо определить структурные факторы слоев А и В.
 |
Рис.2. Двумерное представление сверхрешетки. Каждая колонка описывается подобно рис.1, и дополнительная шероховатость подложки дается смещением толщины tS,k.
Для кристаллического слоя структурный фактор можно записать в виде:
 (22)
(22)
где N, fи d – число атомных плоскостей, атомный фактор рассеяния (одной плоскости), постоянная кристаллической решетки, соответственно. Для различных кристаллических слоев материалов А и В будут различные FAи FB:
 ;
; ![]()
 (23)
(23)
где ![]()
В случае, когда один или оба из слоя сверхрешетки аморфны, считается, что аморфный слой имеет постоянную плотность рассеяния излучения. В таком приближении фактор рассеяния аморфного слоя можно записать как:
![]()
 (24)
(24)
где p – фактор рассеяния единичного объема (объемный фактор рассеяния), tj – толщина слоя.
Чтобы получить, теперь, явное выражение для интенсивности рассеяния сверхрешетки нужно подставить выражения (23-24) в выражение (21) и затем в (20). В результате получится весьма громоздкая формула, включающая и интенсивность рассеяния одной колонкой I(q) (см. рис 1), и вклад в рассеяние всех остальных колонок и шероховатости подложки.
ПРОГРАММА МОДЕЛИРОВАНИЯ РЕНТГЕНОВСКОЙ ДИФРАКЦИИ “SUPREF”
Программа “SUPREF” (SuperlatticesRefinementfromthex-raydiffraction) позволяет производить моделирование спектров дифракции рентгеновского излучения для сверхрешеток. Сверхрешетки представляют собой многослойные структуры с дополнительным дальним порядком повторения роста слоев различных материалов.
Данная программа позволяет моделировать не только однокомпонентные (например, Mo/Ni, Nb/Cu), но и двухкомпонентные сверхрешетки, такие как GaAS/AlAs. Материал каждого слоя задается его атомным номером в периодической таблице Менделеева. В случае же двухкомпонентного материала берется средний атомный номер этих материалов. Параметры слоев материалов задаются следующими значениями: плотностью (dens), постоянной решетки (d(A)), числом атомных плоскостей в соответствующем слое (n) (в случае двухкомпонентных систем число слоев указывается для каждого материала через косую черту).
Беспорядок системы задается:
· отклонениями постоянной решетки от заданных значений (в случае аморфного слоя это просто непрерывное колебание толщины слоя) σd(A);
· отклонением числа атомных слоев от заданного целого значения σn;
· параметрами колебания постоянной решетки вследствие внутрислойного беспорядка Δd1 и Δd2;
· коэффициентом разложения α, определяющим напряжения от прослойки;
· толщиной прослойки между бислоями (dint(A)) и величиной ее колебаний (σdint(A));
Также можно задавать структуру слоев (кристалл / аморфный), число бислоев, величину фона.
Индивидуальные задания.
1
Дано: сверхрешетка GaAs/AlAs.
Цель работы: Исследовать зависимость интенсивности и положения (2θ) дифракционных пиков от числа слоев GaAs, в высокоугловой области.
Ход работы:
1. Запустить программу SUPREF.
2. Выбрать в меню программы последовательно пункты Modeling, GaAskinematical, Editparameters.
3. Установить требуемые пределы по оси Х (для высокоугловой области в пределах 15-70о).
4. Изменяя значение числа слоев n материала А с шагом в 1, 2, 3, 4, 5, 6, 7, 8, 9, 10, 15, 20, 25, 30 слоев проследить значения положения и интенсивности дифракционных пиков.
5. Результаты занести в таблицу и построить графики зависимостей 2θ(n) и I(n).
6. Произвести анализ полученных зависимостей и сделать выводы по проделанной работе.
Примечание: для остальных параметров использовать настройки программы.
2
Дано: сверхрешетка GaAs/AlAs.
Цель работы: Исследовать зависимость интенсивности и положения (2θ) дифракционных пиков от числа слоев GaAs, в низкоугловой области.
Ход работы:
1. Запустить программу SUPREF.
2. Выбрать в меню программы последовательно пункты Modeling, GaAskinematical, Editparameters.
3. Установить требуемые пределы по оси Х (для низкоугловой области <15о).
4. Изменяя значение числа слоев n материала А с шагом в 1, 2, 3, 4, 5, 6, 7, 8, 9, 10, 15, 20, 25, 30 слоев проследить значения положения и интенсивности дифракционных пиков.
5. Результаты занести в таблицу и построить графики зависимостей 2θ(n) и I(n).
6. Произвести анализ полученных зависимостей и сделать выводы по проделанной работе.
Примечание: для остальных параметров использовать настройки программы.
3
Дано: сверхрешетка GaAs/AlAs.
Цель работы: Исследовать зависимость интенсивности и положения (2θ) дифракционных пиков от числа слоев AlAs, в низкоугловой области.
Ход работы:
7. Запустить программу SUPREF.
8. Выбрать в меню программы последовательно пункты Modeling, GaAskinematical, Editparameters.
9. Установить требуемые пределы по оси Х (для низкоугловой области <15о).
10. Изменяя значение числа слоев n материала В с шагом в 1, 2, 3, 4, 5, 6, 7, 8, 9, 10, 15, 20, 25, 30 слоев проследить значения положения и интенсивности дифракционных пиков.
11. Результаты занести в таблицу и построить графики зависимостей 2θ(n) и I(n).
12. Произвести анализ полученных зависимостей и сделать выводы по проделанной работе.
Примечание: для остальных параметров использовать настройки программы.
4
Дано: сверхрешетка GaAs/AlAs.
Цель работы: Исследовать зависимость интенсивности и положения (2θ) дифракционных пиков от числа слоев AlAs, в высокоугловой области.
Ход работы:
13. Запустить программу SUPREF.
14. Выбрать в меню программы последовательно пункты Modeling, GaAskinematical, Editparameters.
15. Установить требуемые пределы по оси Х (для высокоугловой области в пределах 15-70о).
16. Изменяя значение числа слоев n материала В с шагом в 1, 2, 3, 4, 5, 6, 7, 8, 9, 10, 15, 20, 25, 30 слоев проследить значения положения и интенсивности дифракционных пиков.
17. Результаты занести в таблицу и построить графики зависимостей 2θ(n) и I(n).
18. Произвести анализ полученных зависимостей и сделать выводы по проделанной работе.
Примечание: для остальных параметров использовать настройки программы.
5
Дано: сверхрешетка GaAs/AlAs.
Цель работы: Исследовать зависимость интенсивности и положения (2θ) дифракционных пиков от кристалличности слоев, в низко- и высокоугловой области.
Ход работы:
1. Запустить программу SUPREF.
2. Выбрать в меню программы последовательно пункты Modeling, GaAskinematical, Editparameters.
3. Установить требуемые пределы по оси Х (для низкоугловой области <15о, для высокоугловой области в пределах 15-70о).
4. Провести исследование интенсивности и положения (2θ) дифракционных пиков в случаях:
·Кристаллическо/кристаллических слоев;
·Аморфно/кристаллических слоев;
·Кристаллическо/аморфных слоев;
·Аморфно/аморфных слоев;
5. Результаты занести в таблицу.
6. Произвести анализ полученных данных и сделать выводы по проделанной работе.
Примечание: для остальных параметров использовать настройки программы.
6
Дано: сверхрешетка GaAs/AlAs.
Цель работы: Исследовать зависимость интенсивности и положения (2θ) дифракционных пиков от числа бислоев, в низко- и высокоугловой области.
Ход работы:
7. Запустить программу SUPREF.
8. Выбрать в меню программы последовательно пункты Modeling, GaAskinematical, Editparameters.
9. Установить требуемые пределы по оси Х (для низкоугловой области <15о, для высокоугловой области в пределах 15-70о).
10. Изменяя значение числа бислоев (bilay) с шагом в 1, 2, 3, 4, 5, 6, 7, 8, 9, 10, 15, 20, 25, 30, 50, 100, 200,300 слоев, проследить значения положения и интенсивности дифракционных пиков.
11. Результаты занести в таблицу.
12. Произвести анализ полученных данных и сделать выводы по проделанной работе.
Примечание: для остальных параметров использовать настройки программы.
7
Дано: сверхрешетка GaAs/AlAs.
Цель работы: Исследовать зависимость интенсивности и положения (2θ) дифракционных пиков от внутрислойного беспорядка слоев GaAs, в низкоугловой области.
Ход работы:
13. Запустить программу SUPREF.
14. Выбрать в меню программы последовательно пункты Modeling, GaAskinematical, Editparameters.
15. Установить требуемые пределы по оси Х (для низкоугловой области <15о).
16. Изменяя значение внутрислойного беспорядка deld1, deld2 от нуля с шагом в 0.1, проследить положение и интенсивности дифракционных пиков (минимум 10точек).
17. Результаты занести в таблицу, построить графики зависимостей I(deld1), I(deld2), 2θ(deld1), 2θ(deld2).
18. Произвести анализ полученных данных и сделать выводы по проделанной работе.
Примечание: для остальных параметров использовать настройки программы.
8
Дано: сверхрешетка GaAs/AlAs.
Цель работы: Исследовать зависимость интенсивности и положения (2θ) дифракционных пиков от внутрислойного беспорядка слоев GaAs, в высокоугловой области.
Ход работы:
19. Запустить программу SUPREF.
20. Выбрать в меню программы последовательно пункты Modeling, GaAskinematical, Editparameters.
21. Установить требуемые пределы по оси Х (для высокоугловой области интервал 15-70о).
22. Изменяя значение внутрислойного беспорядка deld1, deld2 от нуля с шагом в 0.1, проследить положение и интенсивности дифракционных пиков (минимум 10точек).
23. Результаты занести в таблицу, построить графики зависимостей I(deld1), I(deld2), 2θ(deld1), 2θ(deld2).
24. Произвести анализ полученных данных и сделать выводы по проделанной работе.
Примечание: для остальных параметров использовать настройки программы.
9
Дано: сверхрешетка GaAs/AlAs.
Цель работы: Исследовать зависимость интенсивности и положения (2θ) дифракционных пиков от внутрислойного беспорядка слоев AlAs, в низкоугловой области.
Ход работы:
25. Запустить программу SUPREF.
26. Выбрать в меню программы последовательно пункты Modeling, GaAskinematical, Editparameters.
27. Установить требуемые пределы по оси Х (для низкоугловой области <15о).
28. Изменяя значение внутрислойного беспорядка deld1, deld2 от нуля с шагом в 0.1, проследить положение и интенсивности дифракционных пиков (минимум 10точек).
29. Результаты занести в таблицу, построить графики зависимостей I(deld1), I(deld2), 2θ(deld1), 2θ(deld2).
30. Произвести анализ полученных данных и сделать выводы по проделанной работе.
Примечание: для остальных параметров использовать настройки программы.
10
Дано: сверхрешетка GaAs/AlAs.
Цель работы: Исследовать зависимость интенсивности и положения (2θ) дифракционных пиков от внутрислойного беспорядка слоев AlAs, в высокоугловой области.
Ход работы:
31. Запустить программу SUPREF.
32. Выбрать в меню программы последовательно пункты Modeling, GaAskinematical, Editparameters.
33. Установить требуемые пределы по оси Х (для высокоугловой области интервал 15-70о).
34. Изменяя значение внутрислойного беспорядка deld1, deld2 от нуля с шагом в 0.1, проследить положение и интенсивности дифракционных пиков (минимум 10точек).
35. Результаты занести в таблицу, построить графики зависимостей I(deld1), I(deld2), 2θ(deld1), 2θ(deld2).
36. Произвести анализ полученных данных и сделать выводы по проделанной работе.
Примечание: для остальных параметров использовать настройки программы.
Требования к отчету.
1. Отчет должен быть оформлен в текстовом редакторе Word 97.
2. Отчет должен содержать: название и цель работы, краткие теоретические сведения по предмету исследования, результаты с графиками и таблицами, выполненными в редакторах Origin,Grafer, Word, Excel, анализ полученных данных и выводы по проделанной работе.
Литература.
1. Киттель Ч. Введение в физику твердого тела./Пер. с амер. Гусева и Пахнева, -М.:Наука, 1978, с. 792.
2. Eric E. Fullerton and Ivan K. Schuller, H Vanderstraeten and Y. Bruynseraede. Structural refinement of superlattices from x-ray diffraction. Phys. Rev. (B), vol. 45, N 16 (15 april), 1992.
3. Бублик В.Т., Дубровина А.Н. Методы исследования структуры полупроводников и металлов. -М.: Металлургия, 1978, с. 271.
4.
Материалы
для производства изделий электронной техники./Под ред. Кадыковой Г.Н. и др.
-М.: Высш.шк., 1987, с. 247.