VI. Аппаратура и методы регистрации энергетического распределения вторичных электронов.
6.1. Поверхностная чувствительность и очистка поверхности
 |
В методах электронной спектроскопии информацию о свойствах поверхности получают из анализа распределения электронов по энергии. Для анализа пригодны лишь те электроны, вышедшие из твердого тела, которые не потеряли энергию на своем пути в результате многократных хаотических неупругих столкновений. Такие электроны принято называть характеристическими [1]. Схема возникновения характеристических электронов показана на рис. 6.1. Электроны, возбужденные на достаточно большой глубине от поверхности в результате многократных неупругих столкновений потеряют всю свою энергию и останутся в твердом теле. Часть электронов также испытавших многократные потери энергии, выйдет в вакуум с различными потерями энергии dЕ и дадут вклад в бесструктурный фон в спектре вторичных электронов. Характеристическими, очевидно, будут только те электроны, которые были возбуждены на глубине, меньшей средней длины свободного пробега электронов в твердом теле l. Таким образом, глубина анализируемого слоя определяется величиной l анализируемых электронов.
Результаты экспериментов свидетельствуют (рис. 6.2), что средняя длина свободного пробега имеет минимум, расположенный вблизи 50 ¸ 100 эВ и до некоторой степени не зависит от вещества, в котором движутся электроны. В методах электронной спектроскопии анализируются электроны, энергия которых не превышает 2000 эВ. Из рис. 6.2 видно, что глубина анализируемого слоя для этих электронов не превышает 50 Å. Этим обусловлена высокая поверхностная чувствительность методов электронной спектроскопии. В ряде методов, таких, например, как спектроскопия характеристических потерь энергии электронов, глубину анализируемого поверхностного слоя можно менять, изменяя энергию первичных электронов. Таким способом можно менять глубину анализа приблизительно на порядок – от 5 до 50 Å
Существуют две причины, по которым анализ поверхности должен осуществляться в сверхвысоком вакууме. Во-первых, длина свободного пробега электронов эмитированных поверхностью исследуемого образца, должна быть намного больше размеров спектрометра, чтобы на пути к анализатору они не претерпели рассеяния и, тем самым, не были утрачены для анализа. Согласно молекулярно-кинетической теории газов [2] средняя длина свободного пробега молекул определяется соотношением:
![Подпись:
Рис. 6.2. Универсальная кривая зависимости длины свободного пробега электронов от энергии [1]](./APPARAT.files/image004.gif)
 (6.1)
(6.1)
где kB – постоянная Больцмана; Т – абсолютная температура; d – диаметр молекулы; P – давление.
Оценки средней длины свободного пробега молекул азота для различных давлений приведены в таблице 6.1. Поскольку размеры измерительных камер спектрометров не превышают нескольких десятков сантиметров, то первое условие удовлетворяется уже при давлении 10-5 …10-6 Торр. Эта область давлений соответствует высокому вакууму (ВВ) и реализуется в обычных растровых или просвечивающих электронных микроскопах.
Таблица 6.1.
Кинетические параметры молекул азота при различных давлениях
|
Давление, Торр |
Средняя длина пробега, см |
Скорость поступления частиц, с-1·см-2 |
Время адсорбции монослоя, с |
|
10-2 |
0,5 |
3,8 1018 |
3 10-4 |
|
10-4 |
51 |
3,8 1016 |
3 10-2 |
|
10-5 |
510 |
3,8 1015 |
0,3 |
|
10-7 |
5,1 104 |
3,8 1013 |
30 |
|
10-9 |
5,1 106 |
3,8 1011 |
3000 |
Вторая причина связана с высокой поверхностной чувствительностью методов электронной спектроскопии. Поскольку большинство анализируемых электронов образуется в нескольких верхних атомных слоях, то результаты экспериментов весьма чувствительны к поверхностным загрязнениям любого рода.
Если каким либо способом получена атомарно чистая поверхность для исследования, то адсорбция остаточных газов в камере высокого вакуума будет приводить за время сравнимым с длительностью эксперимента к существенным изменениям состояния поверхности. Скорость поступления частиц на поверхность определяется соотношением [3]:
 , (6.2)
, (6.2)
где P –давление газовой фазы у поверхности; m – масса молекулы.
Для практических расчетов формулу (6.2) удобно представить в ином виде, где давление выражается в миллиметрах ртутного столба, Т в Кельвинах, а масса молекулы заменяется ее молекулярной массой М:
 , (6.3)
, (6.3)
здесь скорость поступления имеет размерность молекула/(cм2×c).
Используя соотношение (6.3), можно вычислить время образования монослоя в предположении, что поверхностная плотность атомов в завершенном поверхностном слое составляет приблизительно 1015 атомов на квадратный сантиметр и все молекулы поступившие на поверхность остаются на ней (коэффициент прилипания равен единице). Полученные таким образом кинетические параметры для молекул азота (N2) при различных давлениях приведены в таблице 6.1.
Поскольку реальный коэффициент прилипания молекул к поверхности значительно меньше единицы, то время образования монослоя значительно больше указанных в таблице 6.1. Для чистых полупроводников (Si, Ge, GaSb, InSb) вероятность прилипания кислорода лежит в интервале 10-2 … 10-4 [4]. Инертные газы практически не остаются на поверхности металлов.
Таким образом, для сохранения атомарно чистой поверхности в процессе эксперимента необходимо поддерживать вакуум 10-9 … 10-10 Торр. Это область сверхвысокого вакуума (СВВ). Современные вакуумные камеры из нержавеющей стали, магниторазрядные и сорбционные насосы позволяют без больших проблем создать и поддерживать необходимое время требуемые условия вакуума.
Для получения достоверных сведений об элементном составе, химических связях и структуре поверхности необходимо в условиях сверхвысокого вакуума очистить исследуемую поверхность от примесных атомов. В настоящее время при очистке insitu наибольшее распространение получили три основные способа:
Скол в сверхвысоком вакууме. Этот способ применим для получения атомарно чистой поверхности материалов, которые легко расщепляются по определенным кристаллографическим плоскостям. Например, монокристаллы германия и кремния раскалываются вдоль плоскости (111), щелочно-галлоидные монокристаллы (NaCl, KCl и др.), кристаллы PbS, PbSe, PbTe, имеющие структуру NaCl скалываются по плоскости (100). Полупроводники типа AIIIBV (InSb, InAs, GaAs, GaSb) расщепляются вдоль плоскости (110) [4].
![Подпись:
Рис. 6.3. Схема устройства для многократного скалывания монокристаллического образца в вакууме [5]](./APPARAT.files/image012.gif) Устройство
для многократного скалывания монокристаллического образца в сверхвысоком
вакууме показано на рис. 6.3. Образец в виде прямоугольного бруска с нарезками
на одной из сторон, расположенных на равном расстоянии друг от друга, для
облегчения процесса скалывания располагается на специальном упоре. Скалывание
производится с помощью металлического клина, вдавливаемого в нарезку. Следующее
скалывание производится после подачи образца в направлении, указанном на
рисунке стрелкой, так, чтобы клин установился напротив очередной нарезки.
Устройство
для многократного скалывания монокристаллического образца в сверхвысоком
вакууме показано на рис. 6.3. Образец в виде прямоугольного бруска с нарезками
на одной из сторон, расположенных на равном расстоянии друг от друга, для
облегчения процесса скалывания располагается на специальном упоре. Скалывание
производится с помощью металлического клина, вдавливаемого в нарезку. Следующее
скалывание производится после подачи образца в направлении, указанном на
рисунке стрелкой, так, чтобы клин установился напротив очередной нарезки.
Недостатки метода получения чистой поверхности сколом в сверхвысоком вакууме связаны с ограниченным числом материалов, пригодных для этих целей. Кроме того, кристаллографическая ориентация поверхности не может быть выбрана произвольным образом. В большинстве случаев поверхность скола имеет достаточно большое количество дефектов, таких, например, как ступеньки и адатомы. Образец можно расколоть лишь ограниченное число раз, что также ограничивает применимость данного метода очистки поверхности.
Нагрев в сверхвысоком вакууме. Этот метод получения чистой поверхности связан с возрастанием скорости десорбции поверхностных атомов с увеличением температуры образца. Эффективность этого метода определяется соотношением между энергией связи адсорбата с поверхностью и энергией теплового движения поверхностных атомов. Температура (в Кельвинах), при которой происходит интенсивная десорбция примесных атомов с поверхностей металлов, может быть оценена по формуле [4]
![]() , (6.4)
, (6.4)
где DH – энергия связи (в ккал/моль) слоя атомов газа, адсорбированного на поверхности данного металла (теплота адсорбции).
Для большинства материалов Т меньше температуры плавления материала Тпл, что делает возможным применения для этих материалов метода термической очистки поверхности в сверхвысоком вакууме. Но для многих металлов и полупроводников Т > Тпл, и их не удается очистить нагреванием. Например, температура плавления германия 1210 К, а теплота адсорбции для GeO и GeO2 составляет соответственно 122 и 129 ккал/моль [4]. Способ термической очистки используется главным образом для тугоплавких металлов, таких как W, Mo и др.
Применение температурной очистки поверхности полупроводниковых материалов неэффективно, так как атомы углерода, составляющие основную долю примесных атомов на поверхности образует с материалом подложки соединения с очень сильной связью. Для удаления окисла с поверхности кремния, например, необходим нагрев образца до 1170 К, однако уже при температуре 1070 К на поверхности кремния образуются его соединения с углеродом, удалить которые значительно труднее, чем соединения кремния с кислородом [6]. Для очистки поверхности монокристаллического кремния разработаны методы, сочетающие предварительную химическую обработку на воздухе с последующим нагревом образца в сверхвысоком вакууме [6,7]. Как правило, очистка проводится в три этапа:
1. Влажная химическая обработка для удаления углерода с поверхности подложки.
2. Создание пассивирующего слоя окиси на поверхности кремния.
3. Термическое удаление окиси кремния с поверхности в сверхвысоком вакууме.
В результате проведения обработки в такой последовательности, температура, при которой происходит полная очистка поверхности кремния от атомов примеси, снижается до 980 К
Наиболее универсальным методом очистки поверхности является бомбардировка ионами инертных газов (ионное травление). На практике обычно для этих целей применяют ионы аргона. Ионы с энергией 0,5 … 5 кэВ, формируемые ионной пушкой, взаимодействуя с поверхностью твердого тела, распыляют поверхностные атомы, как материала образца, так и примесей. Поэтому метод ионной очистки эффективен, даже если скорость удаления частиц примеси намного меньше, чем атомов материала.
Поскольку с помощью ионной бомбардировки можно за сравнительно короткое время удалить большое число атомных слоев, он может быть использован для послойного анализа элементного состава приповерхностных слоев. В этом случае после каждого цикла ионного травления записывается спектр оже-электронов, по которому рассчитываются атомные концентрации элементов на соответствующем расстоянии от поверхности. Подробнее физические основы послойного анализа в электронной спектроскопии обсуждаются в следующем разделе.
Недостатком метода ионного травления является сильное повреждение поверхности. Восстановить структуру поверхности в ряде случаев удается последующим термическим отжигом образца в сверхвысоком вакууме.
6.2 Анализ энергии в электронной спектроскопии
Центральной частью любого спектрометра является энергоанализатор – устройство, позволяющее измерять число электронов, обладающих энергиями, лежащими в заданном интервале. В энергоанализаторах используются физические принципы, связанные с отклонением заряженных частиц в электростатическом или магнитном поле.
Наибольшее распространение в электронных спектрометрах получил энергоанализатор типа цилиндрическое зеркало (АЦЗ). Анализатор этого типа состоит из двух коаксиальных полых металлических цилиндров (рис. 6.4.). Во внутреннем цилиндре A имеются узкие прорези S1 и S2 для прохождения входящих и выходящих электронов соответственно. К внешнему цилиндру B прикладывается отрицательный по отношению к внутреннему цилиндру потенциал Vab. В пространстве между цилиндрами электростатическое поле изменяется обратно пропорционально радиусу r[8]:
 (6.5)
(6.5)
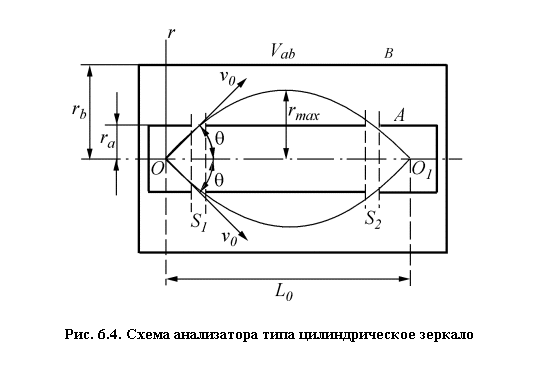 |
здесь ra и rb – соответственно радиусы внутреннего и внешнего цилиндров.
Электроны, влетевшие в энергоанализатор от источника О с некоторой скоростью v0 под углом влета θ, в результате отклонения от первоначальной траектории под действием электрического поля, будут двигаться по криволинейной траектории и сфокусируются на выходе в точке О1, в которой располагается коллектор электронов, например, электронный умножитель.
Наилучшая фокусировка электронного пучка в АЦЗ достигается при угле влета электронов q = 42° 18,5'. В этом случае расстояние между точками О и О1, т.е. между образцом и детектором электронов L0 = 6,12ra. Максимальное удаление электронов от оси анализатора rmax»0,3L0.
Важнейшей характеристикой энергоанализатора является его разрешающая способность R. В случае бесконечно узких входной и выходной щелей через энергоанализатор проходят лишь электроны со строго определенной энергией Е0. При конечной ширине щелей S1 и S2 АЦЗ будет пропускать электроны с угловым разбросом ±Dq и энергетическим разбросом DЕ. Две группы электронов равной интенсивности с некоторой средней энергией Е считаются разрешенными, если при их наложении результирующая кривая имеет минимум. Минимальное энергетическое расстояние между этими группами электронов DЕminпри данном значении Е и определяет разрешающую способность анализатора:
 . (6.6)
. (6.6)
Уменьшить DЕminможно уменьшением ширины щелей, однако при этом уменьшается чувствительность прибора, так как уменьшается доля электронов, достигающих детектора электронов. Пропускная способность анализатора, показывающая какая часть общего потока электронов, испускаемого источником, доходит до детектора, характеризуется светосилой энергоанализатора [9]. Светосила определяется произведением площади сбора электронов на функцию пропускания энергоанализатора [10]. Улучшить разрешающую способность анализатора без уменьшения его светосилы можно уменьшением энергии электронов Е, влетающих в анализатор. С этой целью перед входной щелью анализатора ставят замедляющие электроны сетки или систему электронных линз.
Величина, обратная разрешающей способности анализатора, r = 1/R называется относительным разрешением анализатора. Энергетическое расстояние DЕmin в формуле (6.6) часто называют абсолютным разрешением энергоанализатора. Для АЦЗ r = 0,15…0,5% [9].
![Подпись:
Рис. 6.5. Двухпролетный анализатор типа цилиндрическое зеркало [3]](./APPARAT.files/image022.gif) |
Промышленные анализаторы, совмещающие высокую светосилу с достаточно хорошим разрешением, конструируют на базе двухпролетного АЦЗ, согласованным со сферическими сетками, осуществляющими предварительное торможение электронов (рис. 6.5) [3, 5]. Двухпролетный анализатор, как это видно из рисунка, представляет собой два последовательных обычных АЦЗ. Для измерений с угловым разрешением используется вращающаяся диафрагма, расположенная на входе электронов во второй каскад анализатора.
Соотношение между энергией электронов Е0, регистрируемых АЦЗ, и разностью потенциалов между внешним и внутренним цилиндрами Vab определяется соотношением [5]
 , (6.7)
, (6.7)
где е – заряд электрона.
Наибольшей светосилой и разрешением, сравнимым с АЦЗ, обладает концентрический полусферический анализатор (ПСА). В литературе его часто называют сферическим дефлектором [8,9]. Анализатор этого типа состоит из двух сферических секторов с радиусами кривизны raи rb (рис. 6.6). Электроны в этом случае движутся в поле сферического конденсатора:
![]()
 , (6.7)
, (6.7)
 |
где Vab – разность потенциалов между внешней и внутренней сферами.
Радиус основной траектории электронов
 (6.8)
(6.8)
В режиме фокусировки источник, находящийся в точке О и его изображение, которое расположено в точке О1, лежат на одной линии, проходящей через центр сфер [9]. Отсюда секторный угол j не может превышать p. Зависимость между энергией электрона и приложенной разностью потенциалов определяется соотношением
 (6.9)
(6.9)
Энергетическое разрешение ПСА [5]
![]() ,
, ![]() , (6.10)
, (6.10)
здесь S1– радиус входной апертуры, S2– радиус выходной апертуры, Dq - максимальное угловое отклонение траектории электронов от основной траектории.
Рассмотренные выше энергоанализаторы позволяют регистрировать электроны, обладающие энергиями, лежащими в заданном «окне». В энергоанализаторах этого типа электроны пропускаются через диспергирующее электростатическое поле и их отклонение от первоначальной траектории является функцией электрического поля, приложенного к электродам анализатора. Анализаторы, работающие на этом принципе называются дисперсионными. В электронной спектроскопии широкое применение находит также энергоанализатор с задерживающим полем (АЗП) В этом энергоанализаторе используется тормозящее электростатическое поле, которое пропускает на коллектор только те электроны, кинетическая энергия которых превышает энергию задерживающего электрического поля.
Образец (рис. 6.7) располагается в центре концентрических сферических сеток. Первая сетка находится под тем же потенциалом, что и образец, что гарантирует распространение электронов, покидающих образец, в направлении анализатора в свободном от поля пространстве. На вторую сетку подается отрицательный по отношению к образцу потенциал Us. Изменяя значениеUs, можно регулировать долю электронов, достигших коллектора анализатора. Зависимость тока коллектора IK от энергии задерживающего поля еUs называетсякривой задержки вторичных электронов. Схематический вид кривой задержки в идеальном и реальном случаях представлен на рис. 6.7 внизу. При энергиях задерживающего поля, соответствующих возбуждению в образце определенных групп электронов, например, оже-электронов, ток коллектора резко уменьшается, что приводит к появлению на реальной кривой задержки небольших особенностей.
Ток коллектора связан с интегральной кривой распределения вторичных электронов по энергии N(E) следующим соотношением:
![]() (6.11)
(6.11)
где ES = eUS, ЕР – энергия первичных электронов.
Как видно из соотношения (6.11), для получения зависимости N(E) необходимо продифференцировать кривую задержки вторичных электронов. Повторное дифференцирование кривой задержки позволяет освободиться от достаточно большого бесструктурного фона вторичных электронов и трансформировать особенности кривой задержки в «двойные пики» (рис. 6.7). Для оже-электронной спектроскопии, например, принято представлять результаты в виде дифференциальных спектров dN(E)/dE. Дифференцирование кривой задержки можно осуществить численными методами с использованием ЭВМ, что широко практикуется в современных комплексах для исследования поверхности. В энергоанализаторах с задерживающим полем часто применяют метод электрического дифференцирования кривой задержки, основы которого рассмотрены ниже.
Энергоанализатор с задерживающим полем обладает наименьшим разрешением в сравнении со сферическим дефлектором и анализатором типа цилиндрическое зеркало. Различное энергетическое разрешение рассмотренных выше анализаторов иллюстрирует рис. 6.8, на котором представлены дифференциальные LMM оже-пики поверхности хрома. Все спектры были записаны при идентичных условиях. АЗП вследствие значительного аппаратурного уширения спектральных линий невозможно разделить пики хрома и кислорода, присутствие которого на поверхности металла демонстрирует спектр, полученный с помощью АЦЗ. Ширина оже-пиков в этом случае составляет приблизительно 3 эВ. Сферический дефлектор дает возможность выявления тонкой структуры спектра вторичных электронов, поскольку энергетическое разрешение для спектра, представленного на рис. 6.8 составляет ~0,1 эВ.
![Подпись:
Рис. 6.7. Упрощенная схема энергоанализатора с задерживающим полем, кривая задержки вторичных электронов и спектры, полученные дифференцированием кривой задержки [11]](./APPARAT.files/image042.gif) |
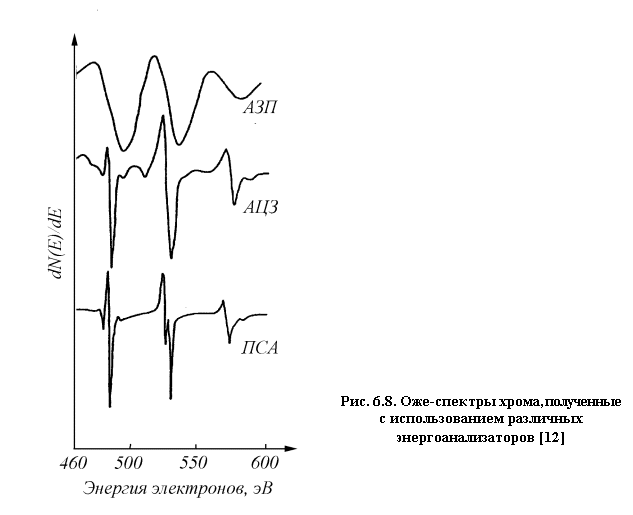
6.3. Электрическое дифференцирование кривой задержки
вторичных электронов.
В электронных спектрометрах, использующих энергоанализаторы с задерживающим полем, обычно применяют метод электрического дифференцирования кривой задержки вторичных электронов, основанный на модуляции задерживающего потенциала [4]. Повторное (двойное) дифференцирование кривой IK(US) позволяет детектировать оже-пики в виде дифференциального спектра dN(E)/dE, т.е. в том виде, который принят в электронной оже-спектроскопии.
Для электрического дифференцирования на задерживающую сетку (рис. 6.7) вместе с постоянным потенциалом US подается небольшое по амплитуде (обычно 0,1 … 5 В) переменное синусоидальное напряжение. В этом случае суммарный потенциал на сетке энергоанализатора будет равен
![]() , (6.12)
, (6.12)
где DU – амплитуда синусоидального напряжения, w - его частота.
С помощью разложения в ряд Тейлора можно показать, что в этом случае ток коллектора может быть представлен как сумма гармоник [3]:
![]() . (6.13)
. (6.13)
Постоянная составляющая тока коллектора I0 определяется соотношением (6.11), амплитуда первой гармоники
 . (6.14)
. (6.14)
Амплитуда второй гармоники
 . (6.15)
. (6.15)
и т.д.
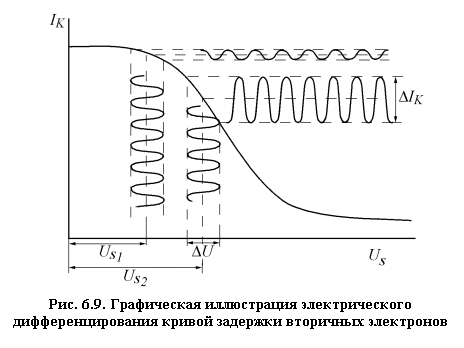 |
Таким образом, сигнал первой гармоники пропорционален N(E). Графическая иллюстрация этого вывода приведена на рис. 6.9. Показана переменная составляющая тока коллектора при двух значениях постоянной составляющей задерживающего потенциала: US1 и US2. Из этого рисунка видно, что амплитуда тока коллектора пропорциональна тангенсу угла наклона кривой IK(US) для данного значения US, т.е. значению производной от кривой задержки для данного значения задерживающего потенциала.
Выделение требуемой гармоники сигнала коллектора осуществляется с помощью синхронного детектирования. Если частота опорного сигнала синхронного детектора равна частоты модуляции w, то на выходе детектора будет сигнал пропорциональный N(E). В случае, когда частота опорного сигнала в два раза больше частоты модуляции, то на выходе синхронного детектора выделяется вторая гармоники, т.е. dN(E)/dE.
Как видно из уравнений (6.14) и (6.15), условия пропорциональности первой гармоники N(E), а второй - dN(E)/dE выполняются лишь при малых значениях модулирующего электрического поля DЕ или, то же самое, при малых значениях амплитуды модуляции задерживающего потенциала DU.
Влияние амплитуды модуляции на соотношение между амплитудами первой и второй гармоник и, соответственно, N(E) и dN(E)/dE для анализатора с тормозящим полем проанализировано в работе [13], в предположении, что оже-пик имеет гауссову форму:
 , (6.16)
, (6.16)
здесь i – полный ток, соответствующий данному оже-пику, s - полуширина гауссова пика на половине высоты.
![Подпись:
Рис. 6.10. Зависимость ошибки амплитуды первой и второй гармоник от амплитуды модуляции [13]](./APPARAT.files/image058.gif) |
Результаты такого расчета для относительного отклонения от пропорциональности между сигналом первой гармоники DА1 и амплитудой модуляции DU, а также относительного отклонения DА2 между сигналом второй гармоники и квадратом амплитуды модуляции (DU)2 для US = 0, т.е при максимуме энергетического распределения, и US = ±s, где максимальна производная распределения электронов по энергии, показана на рис. 6.10.
С ростом амплитуды модуляции зависимость между амплитудой первой гармоники и N(ES) становится все более нелинейной, что обусловлено вкладом членов высших порядков в уравнении (6.14). При DU = s отклонение составляет приблизительно 11%. Нелинейность зависимости амплитуды второй гармоники от квадрата амплитуды модуляции связана с влиянием вклада членов высших порядков в соотношении (6.15). При тех же условиях (DU = s) ошибка в максимумах зависимости dN(E)/dE равна почти 20%. Если двойная амплитуда модуляции меньше полуширины пика, то отклонения обеих величин не превышает 6%.
6.4. Источники электронов, рентгеновского излучения и ионов
В электронных спектрометрах, предназначенных для изучения спектра вторичных электронов, необходимы источники электронов, возбуждающих вторичную электронную эмиссию. Для рентгеновской фотоэлектронной спектроскопии необходимы источники фотонов в рентгеновском диапазоне для возбуждения фотоэффекта. Для целей очистки образцов и получения профилей распределения элементов по глубине необходимы источники ионов для травления поверхности. В современных комплексах для анализа поверхности часто в одной измерительной сверхвысоковакуумной камере размещены все три источника, для обеспечения комплексного исследования поверхности различными методами.
![Подпись:
Рис. 6.11. Основные блоки электронной пушки [14]](./APPARAT.files/image060.gif) |
Источники электронов. В качестве источников первичных электронов в электронной спектроскопии используют электронные пушки, формирующие электронный пучок с соответствующими энергией, интенсивностью и диаметром. Электронные пушки, используемые для исследования поверхности подобны тем, что применяются в обычных черно-белых телевизионных кинескопах или электронно-лучевых трубках осциллографов (рис. 6.11).
Электронная пушка состоит из трех основных блоков. Катодный узел служит для экстракции электронов, которые затем с помощью ускоряющих и фокусирующих электродов фокусируются в электронный луч. Отклоняющие пластины позволяют отклонять электронный луч в горизонтальном и вертикальном направлениях, тем самым, обеспечивая попадание луча в заданную точку поверхности образца. Подача на эти пластины пилообразных напряжений горизонтальной и вертикальной разверток позволяет разворачивать электронный луч в растр по поверхности образца.
В большинстве электронных пушек для получения электронов используют термоэмиссионные катоды. Прямонакальные катоды изготавливают из проволоки чистых металлов (вольфрам, тантал и др.), которой часто придают V-образную форму. Пропусканием электрического тока нагревают эти катоды до температуры, при которой электроны покидают материал катода в результате явления термоэлектронной эмиссии. Вольфрамовые катоды, например, работают при температурах 2500 ¼ 2700 К. При более низких температурах работают подогревные оксидные катоды, катоды из гексаборида лантана (LaB6) и др. До рабочей температуры эти катоды нагреваются внешним нагревателем. Недостатком оксидных катодов является то, что они не выдерживают многократного воздействия воздуха. Этого недостатка нет у металлопористых пропитанных (импрегнированных) катодов [4].
В некоторых промышленных источниках электронов используют автоэмиссионные катоды, испускание электронов в которых осуществляется под влиянием внешнего электрического поля в результате явления автоэлектронной эмиссии. Автоэмиссионные катоды позволяют получать интенсивные электронные пучки со значительно меньшим диаметром, чем термоэмиссионные катоды [4, 10].
Формирование электронного пучка осуществляется системой электростатических или магнитных линз. Наиболее распространенными являются электронные пушки с электростатической фокусировкой. Упрощенная схема электронной пушки с электростатической фокусировкой представлена на рис. 6.12. На этой схеме показан катод с внешним подогревателем в виде нити накала. Модулятор предназначен для регулировки тока первичных электронов. Два анода и фокусирующий электродов образуют электростатическую линзу, с помощью которой формируется узкий пучок электронов с заданной энергией. После прохождения через отклоняющие пластины электроны через дополнительный электрод, называемый «носом» электронной пушки, выходят в аналитическую камеру спектрометра.
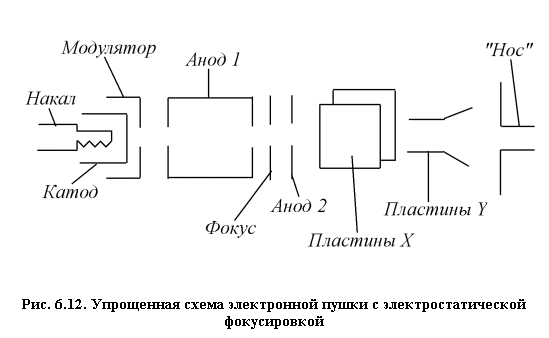 |
Энергия первичных электронов зависит от приложенной разности потенциалов между катодом и анодом электронной пушки и определяется задачами эксперимента. В электронной оже-спектроскопии, например, максимальное сечение ионизации внутренних оболочек атомов электронным ударом имеет место при энергии первичных электронов в 3 … 5 раз превышающей энергию ионизации соответствующего атомного уровня [3]. Например, энергия связи 1s электронов в кислороде составляет приблизительно 515 эВ, поэтому для получения максимальной интенсивности О KLL-пика оже-электронов необходима энергия первичных электронов не ниже 1500 эВ. Большинство промышленных электронных спектрометров работают при энергии первичных электронов от 3 до 10 кэВ.
Источники рентгеновского излучения. В рентгеновской фотоэлектронной спектроскопии в качестве источников мягкого рентгеновского излучения чаще всего используют характеристическое рентгеновское излучение, возникающее при бомбардировке некоторых металлов быстрыми электронами. Поскольку в РФЭС разрешение по энергии должно быть порядка 1,0 эВ, то и ширина линии характеристического излучения не должна быть выше этого значения. Кроме того, энергия фотонов соответствующих линий должна быть достаточной, чтобы возбудить достаточное количество фотоэлектронных линий. Этим критериям наилучшим образом удовлетворяют Ka-линии магния и алюминия [10]. Энергия фотонов составляет соответственно для магния и алюминия 1486,6 и 1253,6 эВ, а ширина линии 0,85 и 0,7 эВ.
![Подпись:
Рис. 6.13. Источник мягкого рентгеновского излучения [10]](./APPARAT.files/image064.gif) |
На рис. 6.13 изображена конструкция простейшего источника рентгеновских фотонов. Анод представляет собой толстую пленку магния или алюминия, напыленную на медную пластину. Источником электронов служит термокатод, находящийся под отрицательным потенциалом до 15 кВ. Катод окружен фокусирующим экраном, который, также как и анод заземлен. Фотоны вылетают через тонкостенное алюминиевое окно, преграждающее путь электронам и возможным загрязнениям. Поскольку при бомбардировке электронами анод сильно разогревается, медная пластина, на которой напылен анод, охлаждается водой.
Часто в РФЭС используют источники рентгеновского излучения с двумя катодами и двумя анодами, один из которых изготовлен из алюминия, другой – из магния. В этом случае переключением извне питания источников электронов, бомбардирующих тот или иной анод, можно перейти от излучения AlKa к излучению MgKa. Такое переключение необходимо при идентификации перекрывающихся фотоэлектронных линий и оже-пиков, присутствующих в фотоэлектронных спектрах. Поскольку энергия фотоэлектронных пиков смещается с изменением энергии фотонов, а положение оже-пиков не зависит от энергии возбуждающего излучения, изменение энергии рентгеновского источника дает возможность разделить эти линии.
Источники ионов. Источники ионов размещаются в сверхвысоковакуумной камере электронного спектрометра для предварительной очистки поверхности образца, а также для использования ионного травления в послойном анализе.
Простейшие ионные пушки используют конфигурацию обычного ионизационного манометра (рис. 6.14). Термокатод эмитирует электроны, которые направляются к сетке, находящейся под положительным по отношению к катоду потенциалом. Перед включением ионной пушки в систему напускают аргон при давлении 10-5 … 10-4 Торр. Ускоренные электроны, соударяясь с атомами аргона ионизуют их в околосеточном пространстве. Цилиндрический ускоряющий электрод, окружающий катод и сетку, находится, в свою очередь под отрицательным потенциалом относительно сетки. Ускоренные этим потенциалом ионы выходят через апертуру ускоряющего электрода и внешнего экрана. Варьируя потенциалы катода, сетки и ускоряющего электрода относительно земли, можно получать ионы с энергией от 200 до 500 эВ. При давлении аргона 10-4 Торр плотность ионного тока может достигать 1 мкА/см2 [10].
![Подпись:
Рис. 6.14. Конструкция ионной пушки, использующей геометрию ионизационного манометра [10]](./APPARAT.files/image066.gif) Ионная пушка,
использующая геометрию ионизационного манометра, не может создавать ионный
пучок диаметром меньше 3 мм. Для фокусировки ионного пучка к системе
электродов, изображенной на рис. 6. 14. добавляют фокусирующие электроды или
фокусирующую систему линз. После фокусирующей системы линз часто ставят
отклоняющие пластины, подобные тем, что используются в электронных пушках, что
позволяет производить сканирование ионным пучком области травления поверхности
образца.
Ионная пушка,
использующая геометрию ионизационного манометра, не может создавать ионный
пучок диаметром меньше 3 мм. Для фокусировки ионного пучка к системе
электродов, изображенной на рис. 6. 14. добавляют фокусирующие электроды или
фокусирующую систему линз. После фокусирующей системы линз часто ставят
отклоняющие пластины, подобные тем, что используются в электронных пушках, что
позволяет производить сканирование ионным пучком области травления поверхности
образца.
В более совершенных ионных пушках используется высоковольтный газовый разряд. Аргон вводится непосредственно в разрядный промежуток, из которого вытягивается и формируется узкий ионный пучок с необходимой энергией. Ускоряющее напряжение ионов может достигать в таких пушках 10 кВ. Рабочий ток зависит от давления в аналитической камере. Например, при давлении порядка 10-6 Торр ток ионного пучка может достигать 200 мкА [10]. Преимущество ионных источников, использующих высоковольтный газовый разряд, кроме возможности получения более интенсивных ионных пучков, связано также с тем, что нет необходимости заполнять аргоном всю рабочую камеру, как это делается при использовании ионной пушки, использующей геометрию ионизационного манометра.
6.5. Электронные спектрометры.
Из анализа физических основ методов исследования поверхности, процессов эмиссии вторичных электронов и способов регистрации распределения электронов по энергии, конструкций вспомогательных устройств, обеспечивающих процесс регистрации электронов, эмитированных поверхностью твердого тела можно сформулировать основные требования к электронному спектрометру.
Для надежной работы электронного спектрометра система получения и контроля сверхвысокого вакуума в аналитической камере спектрометра должна обеспечивать вакуум порядка 10-7 … 10-8 Па. Конструкции современных магниторазрядных насосов позволяют создавать и поддерживать требуемые вакуумные условия в течение длительного времени при достаточно низких энергетических затратах.
Сверхвысоковакуумные камере спектрометров изготавливают, как правило из нержавеющей стали и имеют достаточное количество фланцев для закрепления устройств, обеспечивающих работу спектрометра (электронных и ионных пушек, энергоанализатора и т.д.). Быстрая смена образца обеспечивается шлюзовым устройством, закрепленным на одном из фланцев аналитической камеры. С помощью вакуумных затворов шлюзовая камера отсекается от аналитической камеры, в ней производится смена образца, откачка до предварительного вакуума, после чего образец с помощью специального манипулятора перемещается в аналитическую камеру. При такой процедуре смены образца нет необходимости производить длительную операцию откачки и очистки аналитической камеры.
Манипулятор, на котором крепится образец в аналитической камере, должен обеспечивать возможность перемещения образца в пространстве. Конструкции многопозиционных манипуляторов, применяемых в настоящее время в вакуумной технике, позволяют перемещать образец в трех взаимно-перпендикулярных направлениях, вращать образец, менять угол наклона плоскости образца. В ряде случаев манипуляторы снабжены системой нагревания и охлаждения образца, контроля его температуры, что позволяет производить температурные исследования.
В зависимости от назначения спектрометра в вакуумной аналитической камере располагаются один или несколько анализаторов вторичных электронов. Для электронной оже-спектроскопии, как указывалось выше, вполне подходит по своим техническим параметрам, энергоанализатор типа цилиндрическое зеркало или, в ряде случаев, анализатор с задерживающим полем. Для рентгеновской фотоэлектронной спектроскопии и спектроскопии характеристических потерь энергии высокого разрешения необходим полусферический анализатор или двухпролетный АЦЗ. Последний анализатор находит применение в комбинированных РФЭС- оже-спектрометрах.
В аналитической вакуумной камере располагаются также электронные и ионные пушки. В некоторых спектрометрах применяется вторая электронная пушка для компенсации заряда при записи спектров в непроводящих или плохо проводящих образцах. В спектрометрах, используемых для фотоэлектронной спектроскопии, в аналитической камере располагаются источники рентгеновского или ультрафиолетового излучения.
Работа и управление энергоанализаторами, электронными и ионными пушками, регистрацией сигнала, системами нагрева и охлаждения образцов обеспечивается электронными блоками, которые могут управляться вручную, или с помощью компьютера. В современных автоматизированных комплексах для исследования поверхности компьютерная система управляет основными параметрами спектрометров, такими как кинетическая энергия первичных электронов, ток и напряжение источника рентгеновского излучения, диапазон измерений энергии вторичных электронов, число сканирований и т. д. Компьютерная система контролирует также работу аргоновой ионной пушки и позволяет автоматизировать процесс записи профилей распределения элементов по глубине. Собранные данные можно предварительно обработать с помощью компьютерной системы, произведя операции изменения масштаба спектра, измерения площадей кривых, дифференцирования спектра, устранения выбросов, вычитания постоянной составляющей, сложения и вычитания спектров, сглаживания, вычитания фона, нормировки и анализа сложных спектров, состоящих из нескольких перекрывающихся пиков разной формы и интенсивности и многие другие операции.
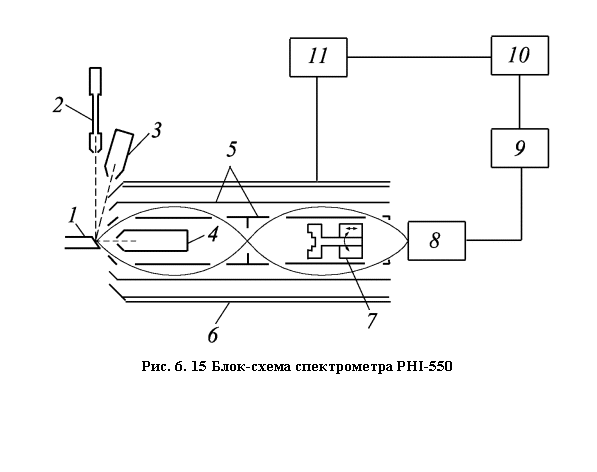 |
В качестве примера на рис. 6.15 представлена блок-схема одного из распространенных РФЭС/ЭОС спектрометров модели PHI-550 фирмы Perkin-Elmer (США). В нем использован двухпролетный АЦЗ, пригодный как для РФЭС так и для ЭОС. Источником рентгеновских лучей служит излучение AlKa или MgKa. Электронная пушка, являющаяся источником первичных электронов, расположена внутри анализатора на его оси. Эмитированные поверхностью твердого тела электроны, прошедшие через анализатор, регистрируются электронным умножителем и детектором импульсов, ионная пушка применяется для предварительной очистки поверхности образца и для профилирования по глубине. Управление спектрометром, контроль за его работой и количественная обработка результатов осуществляется с помощью компьютерной системы.
Разработчики оборудования для исследования поверхности твердых тел стремятся объединить в одном цикле как можно больше методов, дополняющих друг друга при получении информации о физических свойствах поверхностных атомных слоев. ЭОС используется, прежде всего, для определения элементного состава поверхности, РФЭС, СХПЭЭ дают информацию о химических связях атомов на поверхности, УФЭС - о структуре валентной зоны, ДМЭ и ДОБЭ – о кристаллографии поверхностных атомных слоев.
Энергоанализаторы с задерживающим полем предоставляют хорошую возможность для создания на их основе аппаратуры для комплексного исследования поверхности твердых тел. Конструкция этих анализаторов базируется на оптике, давно используемой в исследовании поверхности твердых тел методом дифракции медленных электронов. Поэтому спектрометры, использующие АЗП, позволяют с небольшими конструктивными доработками проводить одновременно с исследованием элементного состава и химического состояния методами ЭОС, СХПЭЭ и др., также структурные исследования поверхностных атомных слоев методом ДМЭ. Используя конфигурацию АЗП, можно коммутацией режимов работы реализовать методы спектроскопии потенциалов исчезновения, спектроскопии пороговых потенциалов и др.
На рис. 6.16 представлена блок-схема электронного спектрометра, предназначенного для комплексного исследования вторично-эмиссионных свойств поверхности твердого тела. Эта лабораторная установка уже в течение нескольких лет используется для учебных и научных целей в Сибирской аэрокосмической академии [15, 16].
Сверхвысоковакуумная камера изготовлена из нержавеющей стали и имеет 10 фланцев различного диаметра. На нижнем фланце крепится магниторазрядный насос, обеспечивающий вакуум до 10-9 Торр. Предварительный вакуум создается сорбционным насосом. Контроль предварительного и высокого вакуума осуществляется соответственно термопарным и ионизационным манометрами. На верхнем фланце сверхвысоковакуумной камеры крепится манипулятор с каруселью для образцов. Держатели образцов снабжены вольфрамовыми нагревателями для очистки образцов в камере СВВ и температурных измерений. Манипулятор позволяет вращать карусель с держателями образцов вокруг вертикальной оси и с помощью трех юстировочных винтов перемещать образец в вертикальном направлении и изменять угол наклона образца относительно электронного луча. Энергоанализатор задерживающего поля с электронной пушкой расположены на одном из боковых фланцев. Коллектор энергоанализатора покрыт люминофором, что позволяет наблюдать картину ДМЭ через окно, расположенное на противоположном от энергоанализаторе фланце. Блок управления электронной пушкой позволяет получать электронный пучок до 5 мкА с энергией до 1500 эВ, разворачивать его в растр, смещать по поверхности исследуемого образца для выбора точки, в которой необходимо записать спектр вторичных электронов. Электронный спектрометр позволяет регистрировать спектр вторичных электронов в виде кривых N(E) или dN(E)/dE. Спектр может быть записан на бланке двухкоординатного самописца или с помощью блока автоматизации записи электронных спектров на базе ПЭВМ в файл для последующей обработки стандартными пакетами прикладных программ.
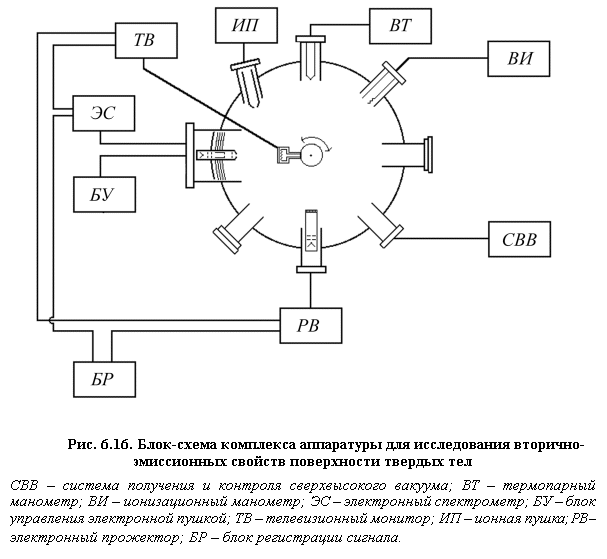 |
Кроме записи спектров вторичных электронов в режиме электронной оже-спектроскопии, спектроскопии характеристических потерь энергии электронов, спектроскопии потенциалов исчезновения и наблюдения дифракции медленных электронов, комплекс аппаратуры позволяет изучать распределение работы выхода по поверхности образца методом электронного пучка (метод Андерсона) [3, 16]. С этой целью на одном из боковых фланцев сверхвысоковакуумной камеры установлен электронный прожектор.
Телевизионный монитор позволяет получать изображение поверхности образца, как в режиме электронного спектрометра, так и в режиме исследования распределения работы выхода по поверхности образца.
Комплекс аппаратуры снабжен также ионной пушкой для предварительной очистки поверхности образцов и изучения профилей распределения элементов по толщине.
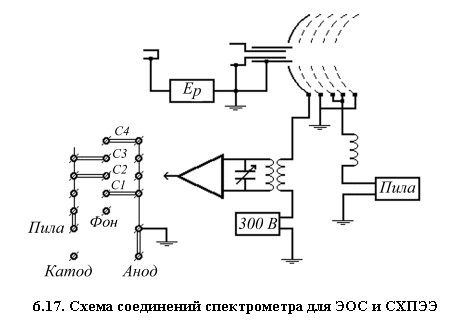 |
Переключение электронного спектрометра с одного режима работы на другой осуществляется с помощью блока коммутации, который позволяет производить в различных вариантах соединения выводов электродов электронной пушки, коллектора, сеток энергоанализатора и источников питания электронного спектрометра. Примеры коммутации режимов для нескольких методов исследования поверхности приведены на рис. 6.17 – 6.19.
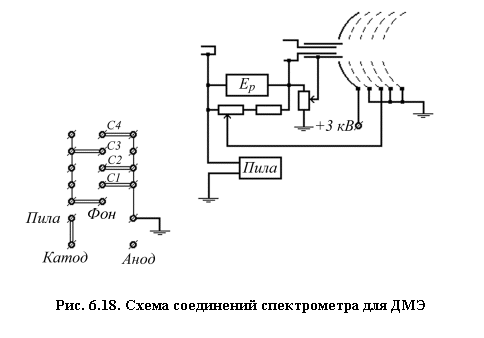 |
 |
В режиме записи оже-спектров или спектров характеристических потерь энергии электронов (рис. 6.17) пилообразный задерживающий потенциал подается на вторую и третью сетки анализатора. На эти же сетки подается через индуктивную связь и напряжение модуляции. Сигнал снимается с коллектора и после усиления селективным усилителем детектируется. Если частота опорного сигнала синхронного детектора равна частоте модуляции, то детектируется кривая N(E), если частота модуляции равна половине частоты опорного сигнала, то регистрируется первая производная от кривой распределения электронов по энергии. Ускоряющее напряжение прикладывается между катодом и ускоряющим анодом электронной пушки, который в этом случае соединен с «носом» пушки.
В режиме наблюдения дифракции медленных электронов (рис. 6.18) на третью сетку подается потенциал, близкий к потенциалу катода электронной пушки. Величина этого напряжения определяет количество электронов с энергией, близкой к энергии упруго рассеянных электронов, достигающих коллектора, и подбирается экспериментально регулировкой фона, на котором наблюдается дифракционная картина. Для наблюдения светящейся картины на люминесцентном слое, покрывающим коллектор, электроны ускоряются потенциалом 3 кВ, приложенным к коллектору. Для изучения зависимости положений и интенсивностей дифракционных максимумов от энергии первичных электронов пилообразное напряжение подается на катод электронной пушки.
В спектроскопии потенциала исчезновения (рис. 6.19) потенциал, подаваемый на вторую и третью сетки энергоанализатора, позволяет, как и в случае ДМЭ, отсечь все электроны, кроме квазиупруго рассеянных. Развертка и модулирующее напряжение прикладывается к катоду электронной пушки, что позволяет, в зависимости от частоты опорного напряжения синхронного детектора регистрировать первую или вторую производную от зависимости коэффициента упругого отражения электронов от энергии первичных электронов.
Литература
1. Фельдман Л., Майер Д. Основы анализа поверхности и тонких пленок.- М.: Мир, 1989.- 564 с.
2. Савельев И.В. Курс физики: Учеб.: В 3-х т. Т.1: Механика. Молекулярная физика.- М.: Наука, 1989.- 352 с.
3. Вудраф Д., Делчар Т. Современные методы исследования поверхности.- М.: Мир, 1989.- 564 с.
4. Шульман А.Р., Фридрихов С.А. Вторично-эмиссионные методы исследования твердого тела.- М.: Наука, 1977.- 551 с.
5. Luth H. Surfaces and Interfaces of Solids, Second Edition, Springer Verlag, Berlin Heidelberg, 1993. - 487 p.
6. Лифшиц В.Г. Электронная спектроскопия и атомные процессы на поверхности кремния. -М: Наука, 1985.- 200 c.
7. Ishizaka A., Shiraki Y. Low temperature surface cleaning of silicon and its application to silicon MBE. // J. Electrochem. Soc., 1986, vol 133, No 4, p. 666 - 670.
8. Фридрихов С.А., Мовнин С.М. Физические основы электронной техники: Учебник для вузов.- М.: Высшая школа, 1982.- 608 с.
9. Еловиков С.С. Электронная спектроскопия поверхности и тонких пленок: Учеб. пособие.- М.: Изд-во МГУ, 1992.- 94 с.
10. Анализ поверхностиметодами оже- и рентгеновской фотоэлектронной спектроскопии / Под ред. Д. Бриггса, М.П. Сиха.- М.: Мир, 1987.- 600 с.
11. Electron Spectroscopy: Theory, Techniques and Applications, Vol. 4 /Eds. C.R. Brundle and A.D. Baker.- Academic Press, London, New York, 1981.- 407 p.
12. Herman M., Sitter H. Molecular Beam Epitaxy: Fundamentals and current status, Springer Verlag, Berlin Heidelberg, 1989. - 382 p.
13. Taylor N.J. Resolution and Sensitivity Considerations of an Auger Electron Spectrometer Based on Display LEED Optics // Rev. Sci. Instr., 1969, vol. 40, No. 6, p. 792 –804.
14. Thompson M., Baker M.D., Christie A., Tyson J.F. Auger Electron Spectroscopy, Chemical Analysis, a Series of Monografs on Analytical Chemistry and its Application, Vol. 74.- Wiley, New York, 1985, 394 p.
15. Физические основы, аппаратура и методы электронной спектроскопии: Метод. указания к лабораторным работам по курсу “Физические основы электронной техники”. Сост. Паршин А.С.- Красноярск: САА, 1993. - 28 с.
16. Эмиссионная электроника: Метод. указания к лабораторным работам по курсу “Физические основы электронной техники”. Сост. Паршин А.С.- Красноярск: САА, 1994. - 38 с.
Купить Весы с печатью этикеток для сетевых магазинов по в Воронеже.